In februari vond de SPIE Advanced Lithography Conference plaats. Ik had onlangs de gelegenheid om Steven Scheer, vice-president Advanced Patterning Process and Materials bij imec, te interviewen en geselecteerde papers die imec presenteerde te bespreken.
Ik vroeg Steve wat de overkoepelende boodschap was bij SPIE dit jaar, hij zei dat paraatheid voor High NA de sleutel is. Hij identificeerde drie belangrijke ecosysteemgebieden:
- Mask and Resolution Enhancement Technology (RET) infrastructuur.
- Materialen, fotoresist en onderlagen.
- Metrologie
De belichtingstools zijn natuurlijk ook belangrijk, maar daar praat Steve niet mee. Opmerking van de auteur: ik zal ook verslag doen van ASML's SPIE-presentaties.
Maskers
Steve somde vervolgens maskergerelateerde problemen op:
- 3D-effecten maskeren, zoals focusverschuiving en contrastverlies – Hoge NA is een belichting vanuit een lage hoek waardoor 3D-effecten een groter probleem worden.
- Maskerblanks met lage defectiviteit en maskers met lage variabiliteit in ruwheid en CD
- Low-n-maskers zijn nodig om een hoger contrast mogelijk te maken en 3D-maskereffecten te verminderen.
- Optische nabijheidscorrectietechnieken.
- Masker schrijven, multibeam.
- Maskersteken - de kleinere omvang van het scannerveld vereist dat de matrijs aan elkaar wordt genaaid.
- 4x één richting, 8x andere richting vereist een nieuw type maskerontwerp om stiksels mogelijk te maken.
- Pellicles voor hogere bronenergie.
In "CNT-pellicles: recente optimalisatie- en belichtingsresultaten," Joost Bekaert et.al. onderzochten Carbon Nanotube pellicles (CNT).
ASML heeft 600 watt bronsystemen op de roadmap staan, de huidige pellicles op basis van metaalsilicide zijn alleen levensvatbaar tot ongeveer 400 watt. Pellicles moeten deeltjes blokkeren, een hoge transmissie hebben, voldoende mechanische sterkte hebben om te worden opgehangen over een gebied van ongeveer 110 mm bij 140 mm, en duurzaam zijn. CNT heeft tot 98% transmissie laten zien. EUV-straling is zo energiek dat het een waterstofplasma creëert dat het vlies etst en uiteindelijk leidt tot verlies van mechanische integriteit van het vlies. imec evalueerde de etssnelheden en hoe het vlies te stabiliseren.
Etssnelheden kunnen worden geëvalueerd door naar transmissie te kijken, aangezien de Pellicle dunner wordt door etsen, neemt de transmissie toe. Figuur 1 illustreert de transmissie in de tijd van een Pellicle onder verschillende omstandigheden.
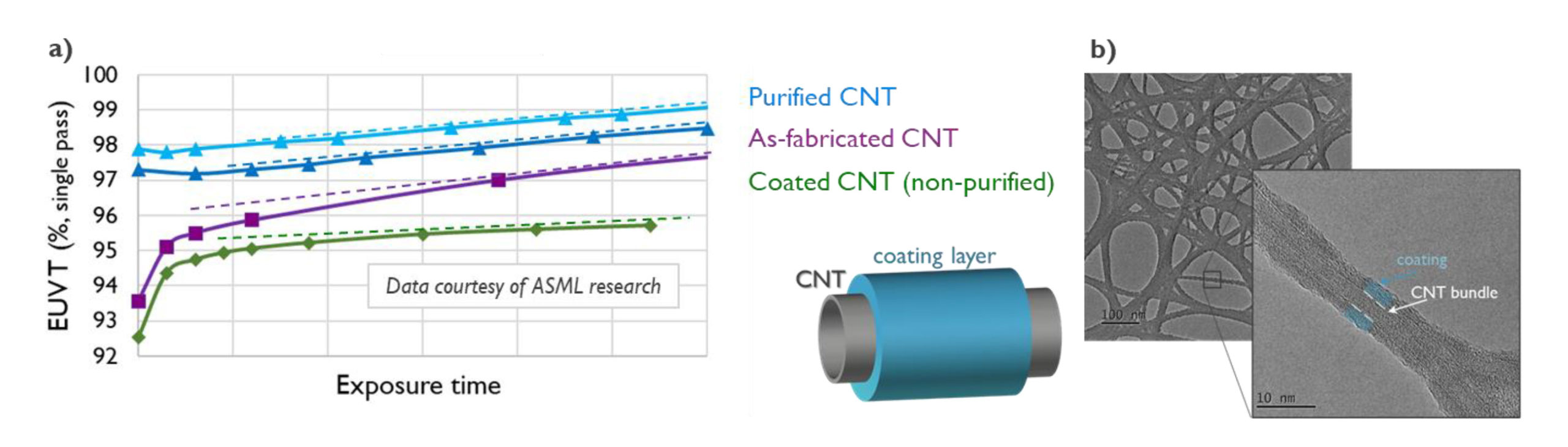
ASML evalueert vliestransmissie versus belichtingstijd met behulp van een offline plasma-belichtingstool en in dit werk demonstreerde imec CNT-vliesblootstelling tot 3,000 wafers (96 sterft bij 30 mJ/cm² per wafer), en toonde correlatie aan tussen de resultaten verkregen uit daadwerkelijke scannerblootstelling en die van de offline tool.
Pellicles hebben aanvankelijk vluchtige organische onzuiverheden uit het productieproces die EUV-energie absorberen totdat ze verbranden, zie de groene en paarse rondingen. Het bakken van het vlies bij hoge temperaturen "zuivert" het vlies door de verontreinigingen weg te branden, wat resulteert in door de etssnelheid gedomineerde transmissieveranderingen. De helling van de twee blauwe krommen is het gevolg van de etssnelheid. De groene curve illustreert een "gecoat" vlies dat een lagere etssnelheid vertoont, maar de coating vermindert de transmissie en is mogelijk niet compatibel met zeer hoge vermogensniveaus.
Fotoresist
Steve, besprak toen fotoresist.
Voor fotoresist is een pitch van 24 nm tot 20 nm een goede plek voor High NA-invoeging met een pitch van 16 nm als ultieme resolutie. Chemically Amplified Resist (CAR) presteert slecht onder 24nm. Metal Oxide Resists (MOR) zien er veelbelovend uit tot 17nm of zelfs 16nm. Defectiviteit is nog steeds een probleem. Doses bij een pitch van 24 nm zijn 67 mJ/cm2 voor MOR en 77mJ/cm2 voor auto. MOR heeft wat stabiliteitsproblemen en hoe lager de dosis, hoe reactiever/minder stabiel de resist is. Dit zijn uitdagingen, geen showstoppers.
In "Verkleinde gedeponeerde onderlagen voor EUV-lithografie," Gupta et.al. onderzochten onderlagen van fotoresist. Naarmate de toonhoogte kleiner wordt, neemt voor dezelfde fotoresistlaag de beeldverhouding toe, wat kan leiden tot het instorten van het patroon. Een verbeterde hechting van de onderlaag kan dit verhelpen. Als alternatief kan een dunnere fotoresist worden gebruikt om de beeldverhouding te beheersen, maar dit kan leiden tot etsproblemen, tenzij een hoge etsselectiviteit onderlaag kan worden gevonden.
imec ontdekte dat de oppervlakte-energie van afgezette onderlagen kan worden afgestemd op de fotoresist om betere hechting te bereiken. Afstemming van de dichtheid van de afgezette onderlaag kan worden gebruikt om verbeterde etsselectiviteit te verschaffen.
In "Dry Resist Patterning Readiness Towards High NA EUV Lithography," Hyo Sean Suh et.al., van imec en Lam onderzochten Lam's droge fotolakproces. Voor N2+- en A14-processen wordt verwacht dat Metal 2 pitch (M2P) ~24nm is met 15nm tip-to-tip (T2T) en dan zal M10P bij A2 ~22nm zijn met <15nm T2T.
Het Lam dry resist-proces wordt geïllustreerd in figuur 2.
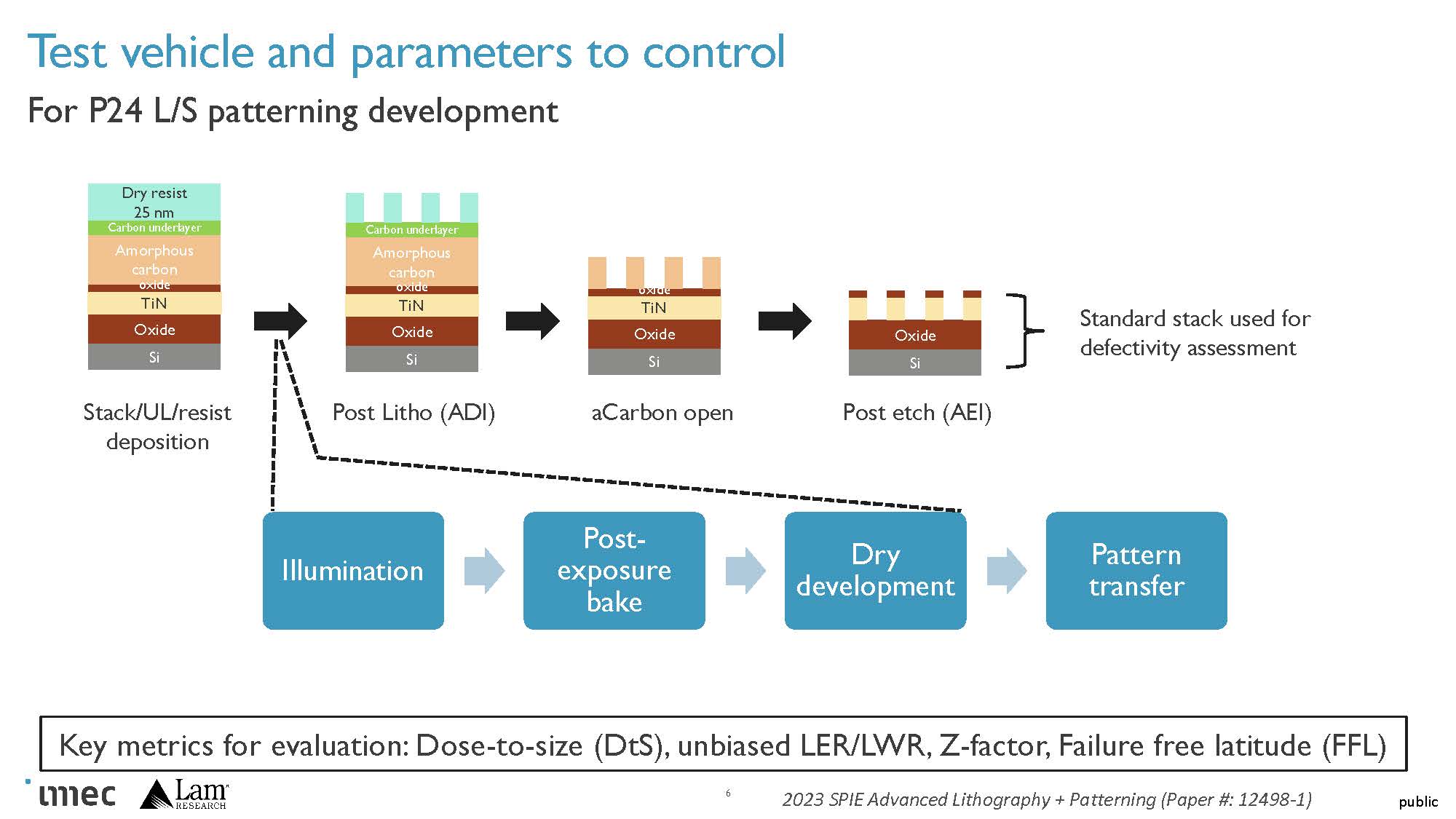
Post Exposure Bake (PEB) bleek de dosisreductie sterk te stimuleren, maar beïnvloedde bruggen en ruwheid. Co-optimalisatie van ontwikkeling en ets vermindert bruggen en ruwheid en toonde een robuust procesvenster voor L/S-patronen met een pitch van 24 nm.
In "Haalbaarheid van logische metaalschaling met 0.55NA EUV single patterning," Dongbo Xu et al. beschreef een evaluatie van wat het High-NA (0.55NA) -systeem kan bereiken met enkele patronen.
Ze concludeerden dat een pitch van 24 nm haalbaar lijkt. 20nm ziet er veelbelovend uit in horizontale richting, maar de verticale richting heeft meer werk nodig. 18nm pitch heeft extra werk nodig.
EUV heeft bewezen een zeer uitdagende technologie te zijn vanuit het perspectief van lijnruwheid en stochastische defecten. Directed Self Assembly (DSA) is een technologie die al heel lang bestaat, maar nog niet veel grip heeft gekregen. DSA krijgt nu aandacht als een techniek om lijnruwheid en stochastische defecten voor EUV aan te pakken.
In "EUV LITHOGRAFIE LIJN RUIMTE PATROON RECTIFICATIE MET BEHULP VAN BLOKCOPOLYMEERGERICHTE ZELFASSEMBLAGE: Een onderzoek naar ruwheid en gebrekkigheid," Julie Van Bel e.a. ontdekte dat het combineren van DSA met EUV superieur is aan DSA-processen op basis van onderdompelingslithografie met een lagere lijnbreedteruwheid en geen dislocatiedefecten.
In "Stochastiek in EUV-lithografie verminderen door gerichte zelfassemblage", Lander Verstraete e.a. onderzocht met behulp van DSA om stochastische defecten in EUV-verwerking te verminderen.
Het imec-proces om lijn/ruimte EUV-defecten te corrigeren wordt geïllustreerd in figuur 3.
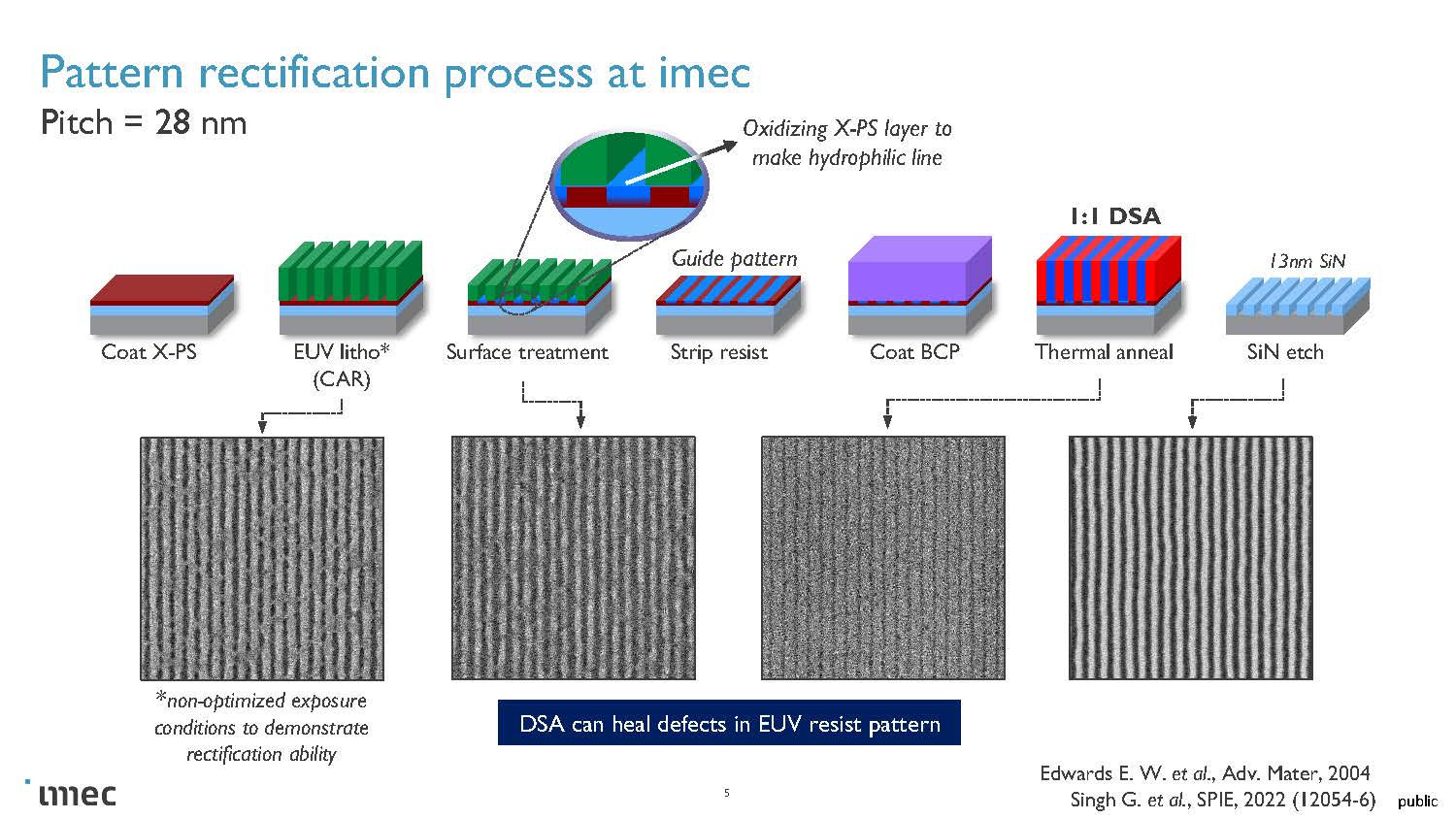
Het imec-proces om defecten in contactarrays te corrigeren wordt geïllustreerd in figuur 4.
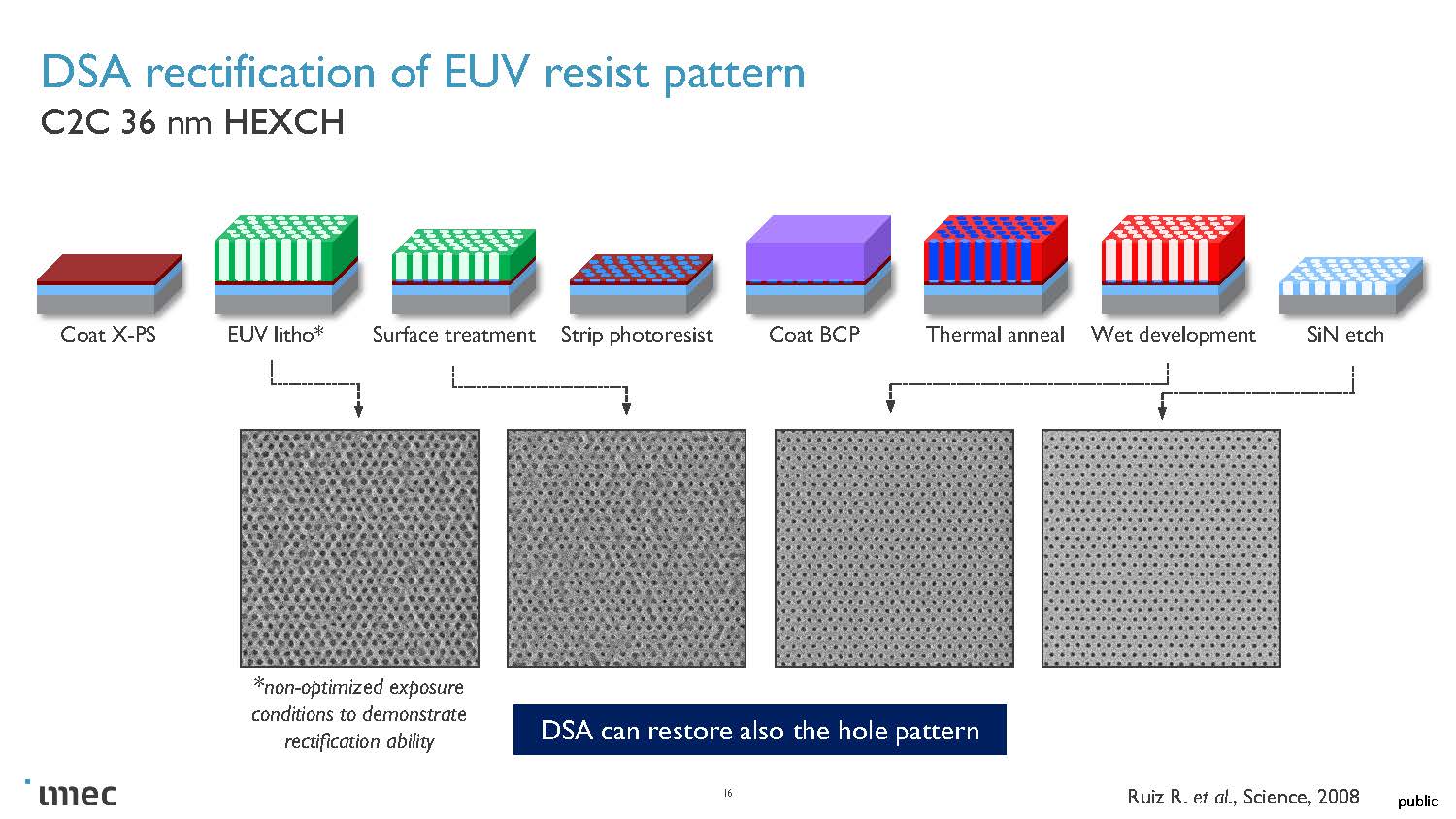
EUV plus DSA ziet er veelbelovend uit voor lijnen/ruimten met een pitch van 28 nm, waarbij bruggen het belangrijkste defect zijn. Bij een 24nm toonhoogte is verbetering nodig bij te veel brugdefecten. Defecten correleren met de blokcopolymeerformulering en annealingstijd.
Voor contactarrays verbetert EUV + DSA de Local Critical Dimension Uniformity (LCDU) en Pattern Placement Error en maakt een lagere dosis mogelijk.
Metrologie
Naarmate filmdiktes afnemen, worden metrologische signaal-ruisverhoudingen een probleem.
Bij EUV is er een venster voor het defectiviteitsproces, aan de ene kant is er een klif waar breuken in het patroon een probleem worden en aan de andere kant van de vensters is er een klif waar bruggen tussen patronen een probleem worden.
Wanneer een nieuwe worp wordt geprobeerd, zijn er veel defecten die in de loop van de tijd worden teruggedrongen.
Het is moeilijk om een voldoende groot gebied met voldoende gevoeligheid te meten. E-straalinspectie is gevoelig maar traag, optisch is snel maar niet gevoelig. Nieuwe 3D-processen zoals CFET introduceren extra uitdagingen.
In "Dry Resist Metrology Readiness for High NA EUVL," Gian Francesco Lorusso et.al, onderzoeken Atomic Force Microscope (AFM), E Beam-inspectie en CD SEM voor karakterisering van zeer dunne fotoresists.
Met behulp van het Lam dry fotoresist-proces bleek CD SEM levensvatbaar te zijn tot een fotoresist van 5 nm dik. Naarmate de resistdikte afnam, nam de lijnruwheid toe, nam de bedrukbaarheid van brugdefecten af, terwijl breukdefecten hetzelfde bleven. Patrooninstorting was alleen te zien in dikkere films. AFM-metingen gaven aan dat de filmdikte afnam. E Beam toonde een goede vastlegging van defecten, zelfs voor hele dunne films.
In "Halfgeleidermetrologie voor het 3D-tijdperk", J. Bogdanowicz et.al., onderzoeken de uitdagingen van metrologie op 3D-structuren.
In het 3D-tijdperk is de Z-richting de nieuwe X/Y-schaling geworden. Voor logische apparaten vormen CFET en semi-damascene uitdagingen, in het geheugen is 3D DRAM een toekomstige uitdaging, en 3D-interconnects voor System Technology Co Optimization (STCO) zijn een andere uitdaging.
Voor horizontale nanosheet- en CFET-processen zijn karakterisering van laterale uitsparing en vulling en het detecteren van residuen en andere defecten in meerlaagse stapels van cruciaal belang. In 3D-geheugen zal high aspect ratio (HAR) hole/split profilering en vergelijkbaar met logica het detecteren van begraven defecten en residuen in films met meerdere lagen van cruciaal belang zijn. Voor STCO-toepassingen zullen integriteit van verbindingsinterfaces en uitlijning van cruciaal belang zijn.
Voor traditionele oppervlaktemetrologie is er al een afweging tussen gevoeligheid en snelheid, nu is inspectiediepte versus laterale resolutie een belangrijke afweging. Figuur 5 toont de sondeerdiepte versus laterale resolutie en doorvoer voor verschillende metrologietechnieken.

Afbeelding 6 vat de huidige gereedheid van 3D-metrologie samen om aan verschillende behoeften te voldoen.

Vanaf figuur 6 zijn er nog veel uitdagingen te overwinnen om tot een uitgebreid metrologieprogramma te komen.
Conclusie
Het tijdperk van High NA EUV nadert. Er wordt goede vooruitgang geboekt op het gebied van pellicles, fotoresists en metrologie en imec blijft op alle drie de gebieden werken aan verdere vooruitgang.
Lees ook:
TSMC heeft veel meer geld uitgegeven aan 300 mm dan je denkt
SPIE Advanced Lithography Conference 2023 – Aankondiging AMAT Sculpta®
IEDM 2023 – 2D-materialen – Intel en TSMC
Deel dit bericht via:
- Door SEO aangedreven content en PR-distributie. Word vandaag nog versterkt.
- PlatoAiStream. Web3 gegevensintelligentie. Kennis versterkt. Toegang hier.
- De toekomst slaan met Adryenn Ashley. Toegang hier.
- Koop en verkoop aandelen in PRE-IPO-bedrijven met PREIPO®. Toegang hier.
- Bron: https://semiwiki.com/lithography/329278-spie-2023-imec-preparing-for-high-na-euv/



