De overstap naar kromlijnige vormen op fotomaskers wint aan kracht na jaren van belofte als een manier om de opbrengst te verbeteren, de defectiviteit te verminderen en de verspilde ruimte op een chip te verminderen - die allemaal essentieel zijn voor zowel voortdurende schaalvergroting als verbeterde betrouwbaarheid in halfgeleiders.
De belangstelling voor deze aanpak was dit jaar groot tijdens de SPIE Photomask Technology + EUV Lithography Conference. Simpel gezegd zijn kromlijnige vormen een nauwkeurigere weergave van kenmerken die op een masker worden afgedrukt en uiteindelijk op een wafer worden geëtst, waardoor een kleinere afstand tussen deze kenmerken mogelijk wordt. Als de hele sector deze aanpak steunt, kan de impact aanzienlijk zijn. Maar er zijn uitdagingen verbonden aan elke stap van deze schaal, vooral omdat deze van toepassing is op de productie van grote volumes, en de transitie is niet triviaal. Bovendien zal het, zelfs als er brede steun is, jaren duren voordat de voordelen volledig worden gerealiseerd.
“Curvilinear bestaat al een tijdje”, zegt Steffen Schulze, vice-president van Caliber semiconductor solutions bij Siemens EDA. “Er zijn demonstraties van de technologie geweest, zoals geheugenbedrijven die deze gebruikten in arrays met hoge dichtheid en een hoge herhalingssnelheid, maar deze was altijd gebonden aan het productieframework. Nu lijkt het bijna alsof de dam is gebroken omdat hij kromlijnig is geworden.”
Er is zeker meer optimisme over het potentieel ervan. “Mensen praten al tientallen jaren over kromlijnige maskers”, zegt Chris Mack, CEO van Fractilia. “Maar er is altijd een kosten-batenverhouding geweest, en de kosten zijn groter dan de voordelen. Nu hebben een paar belangrijke factoren die kosten-batenverhouding veranderd, en kromlijnige maskers zouden wel eens praktisch kunnen zijn.”
Eén van deze factoren is de adoptie van meerstraals masker schrijvers. Historisch gezien was het schrijven van maskers afhankelijk van e-beam-lithografie met één bundel, wat tijdrovend en minder efficiënt is voor het creëren van complexe patronen. Met de stijgende vraag naar ingewikkelde ontwerpen en kleinere knooppunten wordt de behoefte aan sneller en nauwkeuriger maskerschrijven echter duidelijk. Deze tools werden begin 2010 geïntroduceerd en brachten een revolutie teweeg in de productie van maskers door het gelijktijdig schrijven van meerdere patronen mogelijk te maken, de schrijftijden drastisch te verkorten en de creatie van complexere ontwerpen mogelijk te maken.
“Multi-beam maskerschrijvers bestaan al enkele jaren”, zegt Aki Fujimura, voorzitter en CEO van D2S. “Nu, vooral voor EUV, worden maskers bijna altijd voor 100% geschreven door maskerschrijvers met meerdere bundels. Er is geen extra straf voor het hebben van kromlijnige vormen, omdat het produceren van ronde maskers geen extra tijd kost.
Dat pleit voor kromlijnig adoptie veel eenvoudiger. “De industrie is al bezig met een kromlijnige trend”, zegt Travis Brist, senior productmarketingmanager bij Synopsys. “Het datavolume was een barrière, die soort van 'in de maak' is, en de maskerschrijver was een barrière. Maar de schrijvers van maskers met meerdere bundels beginnen op de markt te komen, en je begint daar steeds meer gebruik van te zien.”
De prestaties van deze apparatuur zijn dramatisch verbeterd. "Bij het ouderwetse maskerschrijven schreven we pixel voor pixel", voegt Mack toe. “En met een kromlijnig masker zou je een kleinere pixelgrootte en een kleinere adresgrootte moeten hebben, wat de schrijftijden dramatisch zou verhogen, en dus de kosten van het masker. Maar de afgelopen tien jaar hebben we gezien dat schrijvers van maskers met meerdere bundels beschikbaar en populair werden. Nu kunnen ze een kromlijnig masker schrijven met dezelfde snelheid als een Manhattan-geometriemasker – en ook met hoge nauwkeurigheid.”
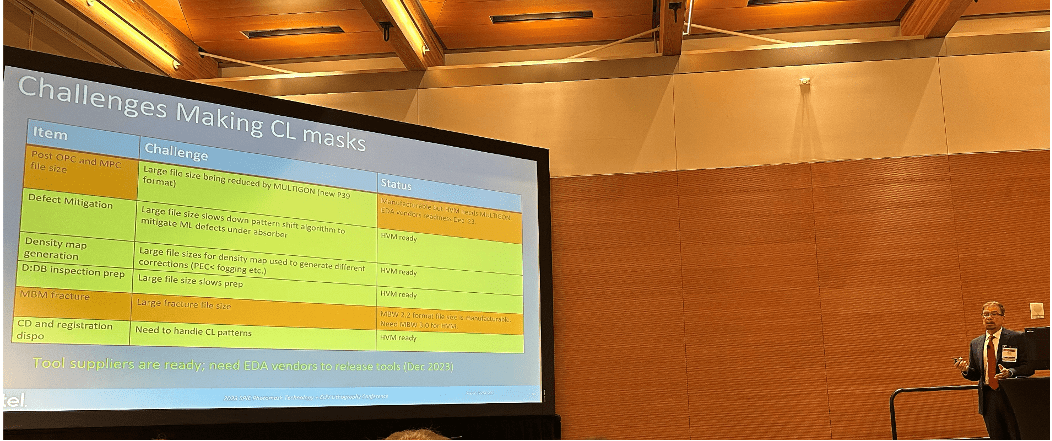
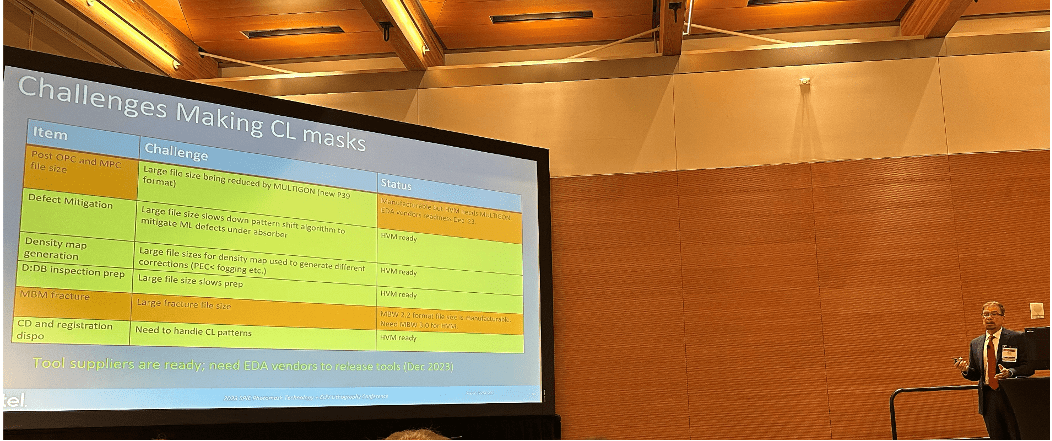
Fig. 1: Frank Abboud van Intel bespreekt uitdagingen op het gebied van kromlijnige maskers bij SPIE. Bron: Semiconductor Engineering/Gregory Haley
Een andere belangrijke factor die kromlijnige maskering mogelijk maakt, is het “multigonale” formaat voor het weergeven van kromlijnige kenmerken. Multigon – een verzameling polygonen in een enkele geometrie – is speciaal ontworpen om kromlijnige kenmerken weer te geven en zorgt ervoor dat gegevensvolumes beheersbaar blijven, ondanks de ingewikkelde aard van deze ontwerpen.
“Inverse lithografie, of kromlijnige lithografie, werd meer dan tien jaar geleden gecreëerd”, zegt Kurt Ronse, directeur van het geavanceerde patroonprogramma bij imec. “Het probleem was dat het willekeurige patronen op het masker waren, en soms hele kleine patronen en grotere patronen en allerlei oriëntaties, dus niemand kon zo’n masker maken. Bovendien was er geen methode om deze afbeelding, die je had berekend, op te slaan in een standaard gegevensformaat. De gegevens werden veel te groot en een maskerwinkel kon deze niet in de schrijver laden.”
Dit is een van de uitdagingen bij kromlijnige vormen. Een rechte lijn kan worden gedefinieerd door twee punten, maar voor een gebogen lijn zijn veel punten langs de curve nodig om een nauwkeurige weergave te krijgen, en als je veel golvingen hebt, heb je veel punten nodig. Het datavolume voor een dergelijk ontwerp zou enorm zijn.
Dat is waar het multigon-formaat in het spel komt. In plaats van uitsluitend te vertrouwen op stuksgewijs lineaire representaties, introduceert het multigon-formaat methoden om kromlijnige polygonen weer te geven, zoals de kwadratische Bézier-curve-fitting of spline-fitting. Deze methoden kunnen de essentie van een kromlijnige vorm vastleggen met minder datapunten, wat mogelijk kan leiden tot kleinere bestandsgroottes en efficiëntere gegevensverwerking.
"Kubische splines zijn de meest voorkomende multigonen waar mensen naar kijken, omdat ze erg flexibel zijn", zegt Mack. “Stel een paar kubieke splines samen en je kunt een behoorlijk complexe vorm beschrijven met een veel kleinere reeks cijfers. Maar dat is een standaardisatie-inspanning waarvoor de hele industrie moet samenwerken om dat mogelijk te maken. En dat werk gaat door. Het zal heel nuttig zijn als het klaar is.”
Zelfs de overstap naar dit formaat is ingewikkeld. "Naast deze gebogen kenmerken zorgt curvilineair voor veel meer datavolume en complexiteit", zegt Brist van Synopsys. “Dus we kijken naar het multigon-formaat als een andere manier om de gegevens in het GDS-bestand weer te geven om het volume te verminderen, en naar zaken als AI en machine learning om met de complexiteit van de gegevens om te gaan en de implementatie sneller te maken.”
Bestaande tools en processen die zijn geoptimaliseerd voor Manhattan-structuren kunnen onnauwkeurige resultaten opleveren met kromlijnige vormen. Dit vereist de ontwikkeling van nieuwe tools, algoritmen en controles om effectief om te gaan met de complexiteit van kromlijnige ontwerpen.
"Je kunt je voorstellen dat, nu je deze gebogen kenmerken hebt, dingen die gewend zijn aan het kijken naar Manhattan-structuren en het nemen van metingen tussen Manhattan-kenmerken, niet meer werken voor gebogen kenmerken", voegt Brist toe. “Je moet dus echt nieuwe soorten controles creëren om deze kenmerken te identificeren zonder valse positieven te identificeren of dingen te missen. Dat wordt een nieuwe uitdaging.”
Controleren op gebreken
Maskerregelcontroles (MRC's) zijn lange tijd de hoeksteen geweest van het ontwerp en de productie van halfgeleiders. Deze regels zorgen ervoor dat fotomaskerpatronen kunnen worden vervaardigd en dat zij de beoogde kenmerken op de siliciumwafel getrouw en zonder gebreken reproduceren. Historisch gezien waren MRC's op maat gemaakt voor (rechtlijnige) structuren in Manhattan, gekenmerkt door hun rechte hoeken en rechtlijnig ontwerp. Naarmate de sector echter verschuift naar kromlijnige of niet-Manhattan-kenmerken, worden de beperkingen van traditionele MRC's duidelijk. Deze conventionele controles hebben moeite om effectief om te gaan met de nuances van gebogen kenmerken, wat leidt tot mogelijke onnauwkeurigheden, valse positieven of over het hoofd geziene details.
“Het controleren van maskerregels in de wereld van Manhattan is redelijk goed gedefinieerd, maar we werken samen met klanten om nieuwe maskerregels te identificeren die verband houden met de kromlijnige gegevensrepresentatie”, zegt Stephen Kim, directeur masker- en platformoplossingen bij Siemens EDA. “Ik denk niet dat die regels definitief zijn vastgelegd, maar naarmate ze zich voordoen, zullen ze conventies versterken die hopelijk veel mensen kunnen gebruiken.”
De voordelen van deze aanpak zijn al lang bekend. “Met Manhattan-maskers word je echt beperkt door de MRC-beperkingen wat betreft hoe dicht je dingen bij elkaar kunt voegen”, voegt Brist toe. “Als je vier randen van 90° hebt, loop je al snel tegen deze beperkingen aan en kun je zien hoe het gedrukte contact daar wordt aangetast.” (zie figuur 2). “Als je kunt overstappen op een curve-regime, voldoe je nu nog steeds aan de MRC-beperking. Maar omdat het gebogen is, krijg je feitelijk meer dekking en kun je dingen dichter bij het doel afdrukken. We zien strakkere CD-bedieningen, minder CD-variabiliteit, lagere MEEF – al deze pluspunten.” (De maskerfoutverbeteringsfactor, of MEEF, is de verhouding van de CD van fotoresist met patroon op de wafer ten opzichte van de kritische dimensie van het masker.)


Fig. 2: Manhattan-maskers worden meer beperkt door MRC-beperkingen dan kromlijnige maskers. Bron: Synopsys
Een mogelijke stikoplossing voor EUV met een hoge NA
Een andere uitdaging voor het gebruik van kromlijnige maskers is de noodzaak om twee maskers aan elkaar te naaien om een compleet beeld op de wafer te vormen. Voor EUV met een hoge NA zijn stikfouten voor het halfveldmasker een groot probleem.
Stel je voor dat je een lijn door een veld trekt, waarbij je onbedoeld minuscule fragmenten of ‘splinters’ achterlaat. Deze kleine kenmerken moeten vervolgens op een volgend masker worden weergegeven. In plaats van een rechte lijn door het veld te trekken, kan het strategischer zijn om de lijn enigszins aan te passen zodat deze deze strookjes binnen de primaire polygoon omvat. Deze aanpak vereenvoudigt de taak, waardoor de puzzelstukjes harmonieuzer in elkaar passen, maar vereist AI/ML om de berekeningen uit te voeren.
“De stitching-uitdagingen voor hoge NA zijn redelijk goed bekend”, zegt Ronse van imec. “Een van de dingen die compleet nieuw is bij hoge NA is het anamorfe karakter van de lens, dat de grootte van het printgebied op de wafer beperkt. De vergroting op het masker van het ontwerp is 8X in één richting, in plaats van twee keer 4X. De andere richting is nog steeds 4X. Met maskers van 33 cm kun je slechts de helft van de veldgrootte op de wafer belichten. Als je een chip hebt die lijkt op de typische 26 x 15, kun je slechts 16 of XNUMX millimeter scannen, en dan heb je een ander masker nodig om de andere kant van de chip in beeld te brengen. En uiteraard moeten ze bij elkaar passen. Dat is een grote zorg. Niemand heeft dat ooit gedaan.”
Er bestaat mogelijk een onorthodoxe oplossing voor de stikproblemen bij hoge NA, die onlangs werd gepresenteerd door een aantal grote chipfabrikanten. Het basisidee is om de grootte van het typische dradenkruis van 6 x 6 inch te verdubbelen tot een masker van 6 x 12 inch, waarmee een hele chip in één keer kan worden afgebeeld op een scanner met een hoge NA en de uitdagingen van het naaien kan worden vermeden. Maar zo’n grote verandering in de manier waarop fotomaskers worden gekraakt, zou niet eenvoudig zijn.
“Maskerfabrikanten zouden in principe veel grotere blanco’s moeten schrijven, schoonmaken en coderen, en ze zouden dikker moeten zijn om doorzakken te voorkomen”, zegt Ronse. “Ze zullen veel zwaarder zijn.”
Of maskerbedrijven deze aanpak zullen volgen, is nog onbekend. "Er bestaat enige sceptische kijk op deze kwestie, en of dit iets is waar de industrie klaar voor is", aldus Schulze van Siemens. “Maar de consensus lijkt te zijn dat het meer een technisch probleem is dan een wetenschappelijk probleem. Als dat de weg is die mensen kiezen, zou het een aantal jaren duren om daar te komen.”
En dit is waar de industrie zich vandaag de dag bevindt. “Wat ze eigenlijk zeiden is dat als de hele industrie tegen het einde van het jaar op één lijn zit, ze deze zullen gaan ontwikkelen”, zegt Ronse van imec. “Als de sector niet op één lijn zit, zullen ze dat natuurlijk niet doen, omdat het een dure exercitie zal worden. Maar het belangrijkste is dat je stiksels kunt vermijden. En ten tweede zou de doorzet minimaal 50% hoger zijn, dus dat brengt feitelijk de kosten omlaag.”
Maar er zijn ook compenserende factoren. “Er wordt zeker rekening mee gehouden hoe zwaar dit nieuwe maskerformaat zal zijn”, voegde Kim van Siemens eraan toe, en merkte op dat er een aantal gestandaardiseerde specificaties voor nodig zijn. “Dit geeft de industrie iets om over na te denken en problemen die kunnen worden verwacht, zodat die discussie kan plaatsvinden zodra we dergelijke specificaties hebben.”
Zelfs als iedereen het ermee eens is, zal de implementatie ervan tijd vergen. “[Het ontwikkelen van de] nieuwe apparatuur die nodig is om de grotere maskers te kunnen hanteren met een nieuwe set substraten is waarschijnlijk een ontwikkelingstijdlijn van vijf jaar”, voegde Schulze eraan toe. “Dat betekent dat we ons in de tussentijd moeten concentreren op het oplossen van de stikproblemen.”
Kromlijnige maskers op kleinere knooppunten
Net als andere technologieën die oorspronkelijk voor de leading edge zijn ontworpen en die uiteindelijk doorsijpelen naar andere gebieden in de stroom, zal kromlijnig maskerschrijven waarschijnlijk ook naar oudere processen migreren. Naarmate de technologie volwassener wordt en fabrieken betere modellen en procesrecepten krijgen voor kromlijnig, is er geen reden waarom kromlijnig niet zou worden gebruikt voor oudere procesknooppunten.
“Het komt erop neer of het voordeel de extra kosten rechtvaardigt”, zegt Mack van Fractilia. “Als er een wens bestaat om kromlijnige maskers voor EUV te gebruiken, komt dat waarschijnlijk omdat de EUV-lagen de hogere kosten rechtvaardigen. Er kunnen ook 193 lagen zijn die het betalen van de kosten rechtvaardigen, en de kosten zullen waarschijnlijk dalen naarmate het gebruik ervan toeneemt – in welk geval meer dan 193 lagen gerechtvaardigd zouden kunnen zijn bij het gebruik van kromlijnige maskers. Dat gezegd hebbende, gaat niemand terug en verandert een reeds lopend proces, maar elk nieuw proces bevat nog steeds een heleboel 193 lagen.”
Schaalvoordelen treden op een gegeven moment op. “Zodra kromlijnig nog meer beschikbaar wordt, en misschien als de kosten voor het maken van die maskers dalen, zul je het gebruik van kromlijnig niet alleen zien in EUV en hoge NA”, zegt Brist. “Het zal draaien op oudere technologieën die voorheen beperkt waren tot functies in Manhattan-stijl. In plaats van multi-patterning op een ouder knooppunt uit te voeren, of misschien zelfs op zoek te gaan naar een nieuwe tool, kunnen bedrijven de levensduur van hun bestaande tools verlengen door gebruik te maken van deze kromlijnige maskers.”
Dat zorgt op zijn beurt voor een veel langere staart voor besparingen. “Naarmate de industrie volwassener wordt, en naarmate deze technologie volwassener wordt, lijkt het waarschijnlijk dat deze zich verder zal verspreiden vanwege de voordelen die je krijgt op het gebied van spanning en stroom, verminderde aantallen, en lagere kosten.” vult Schulze aan.
Resterende uitdagingen voor kromlijnig
Er zijn nog twee andere belangrijke uitdagingen die moeten worden overwonnen voordat kromlijnige bewegingen naar de reguliere productie gaan. Eén daarvan is het gebrek aan bestaande modellen en geschiedenis waarop kan worden geput voor nauwkeurige berekeningen.
“Ervaring is zo belangrijk voor onze branche”, zegt Mack. “We maken ongelooflijk complexe apparaten met ongelooflijk complexe processen, en we vertrouwen op onze geschiedenis van wat werkt en wat niet om ons te informeren. Incrementele veranderingen zijn veel gemakkelijker om mee om te gaan, omdat we kunnen profiteren van onze productiegeschiedenis om te begrijpen waar we op moeten letten en wat we moeten negeren. Maar het gebruik van kromlijnige maskers is een verandering die zo groot is dat er veel geleerd moet worden om ons gebrek aan ervaring te overwinnen.”
Dit soort verschuiving kost tijd, moeite en brede betrokkenheid van de industrie. "Met Manhattan-ontwerpen beschikken we over een mooie, rijke database waarin we kunnen putten uit rijke ervaring en kennis", aldus Fujimura van D2S. “De tribale kennis bouwt zich in de loop van de tijd op, maar dat weten we niet voor de kromlijnige dingen. Voor CD is het in de industrie een gevestigde waarde dat het allemaal hetzelfde is. Dus als je die cijfers hebt om te vergelijken, weten mensen dat het een zinvolle vergelijking is. Hoewel dit een technische barrière opwerpt voor curvilineariteit, is het niet de vraag: 'Kun je het doen?' Het is meer: 'Wat is de conventie?'”
Een andere grote uitdaging voor kromlijnige maskers is inspectie. Traditionele inspectietools zijn geoptimaliseerd voor Manhattan-ontwerpen, die worden gekenmerkt door hun rechtlijnige, rechthoekige structuren. Met kromlijnige maskers neemt de complexiteit exponentieel toe. De ingewikkelde en gevarieerde patronen op deze maskers maken het voor conventionele gereedschappen moeilijk om defecten snel en nauwkeurig te identificeren. Bovendien kan de enorme hoeveelheid gegevens die verband houden met kromlijnige ontwerpen deze tools overweldigen, wat leidt tot langere inspectietijden en mogelijke vergissingen. Nu de industrie zich steeds meer richt op kromlijnige maskering, is er een dringende behoefte aan het ontwikkelen van geavanceerde inspectiemethoden die efficiënt met de nuances van deze ontwerpen kunnen omgaan en tegelijkertijd de hoogste niveaus van nauwkeurigheid en precisie garanderen.
“Op dit moment is de barrière de inspectie”, zegt Ronse van imec. “Als je een kromlijnig masker hebt, moet je het inspecteren om te zien of alles in orde is en of er gebreken zijn. Maar de inspectietool kan niet de hele plaat inspecteren omdat er veel te veel gegevens zijn. Nu worden de inspectietools voorbereid om dit nieuwe dataformaat voor kromlijnige lijnen te accepteren, maar dat is vandaag de dag waarschijnlijk nog steeds het grootste probleem.”
Kromme maskerinspectie
Er zijn in wezen twee soorten inspectieparadigma's. Eén daarvan is een vergelijking tussen sterven en sterven. Typische maskers hebben meer dan één chip, en een heel eenvoudige manier om ze te inspecteren is door de ene dobbelsteen met de andere te vergelijken. Een camera met hoge resolutie kijkt naar een foto van één regio, kijkt naar een foto van dezelfde regio op de verschillende dobbelstenen en vergelijkt de verschillen. Elk verschil kan een defect vertegenwoordigen, omdat alle afbeeldingen identiek moeten zijn.
Er is altijd de mogelijkheid dat defecten zich herhalen, omdat elke dobbelsteen hetzelfde defect kan hebben. Dat kan worden veroorzaakt door een fout in de ontwerpgegevens. Toch zijn deze gevallen ongebruikelijk. Normaal gesproken is het een willekeurig defect of een defect dat voortkomt uit de mogelijkheid om een bepaald kenmerk op het masker aan te brengen. Meestal kunnen alle defecten worden geïdentificeerd met een die-to-die-inspectie.
Er is echter het geval dat u slechts één chip per masker heeft, of, in het geval van kromlijnige ontwerpen, een halve chip per masker. Tien vergelijkingen van sterven tot sterven zijn niet mogelijk. In plaats daarvan gebruik je die-to-database-inspectie, waarbij je een database hebt van hoe de ontwerpgegevens eruit moeten zien en je het eigenlijke masker hebt, en dan doet de ingenieur de vergelijking. Vergelijkingen tussen databases en databases zijn aanzienlijk ingewikkelder en zeer rekenintensief vergeleken met vergelijkingen tussen databases.
“Momenteel zijn er drie mogelijke oplossingen voor inspectie”, zegt Fujimura. “Er is traditionele die-op-die-inspectie. Dan is er actinisch, dat voor inspectie dezelfde golflengte van licht gebruikt als bij het lithografieproces. En dan is er nog de e-beam-inspectie, die twee vormen kan hebben. Een daarvan is dat ze maskers via e-beam inspecteren. Of ze kunnen e-beam-inspectie uitvoeren op wafers die met maskers zijn bedrukt. In sommige opzichten zijn er gewoon te veel potentiële technologieën en kunnen de focus en financiering van de industrie verwateren.”
Conclusie
Het tijdperk van kromlijnige maskering is aangebroken. De volgende stap is om het naar HVM te brengen, maar dat brengt een aantal uitdagingen met zich mee die in de hele sector agressief moeten worden aangepakt. Van maskerschrijvers met meerdere bundels tot meerhoekvergelijkingen en de mogelijkheid van grotere dradenkruisen: processen voor het maken, berekenen en veranderen van de manier waarop fotomaskers worden gemaakt en gebruikt.
In een recente presentatie noemde Frank Abboud, vice-president technologieontwikkeling voor Intel's maskeroperatie en wafer fab-metrologie, kromlijnig 'mooi'. “Het heeft waarde. Het heeft waarde voor de golfvorm. Het heeft waarde voor de OPC-motoren. Het heeft veel waarde en we moeten het waarmaken.”
- Door SEO aangedreven content en PR-distributie. Word vandaag nog versterkt.
- PlatoData.Network Verticale generatieve AI. Versterk jezelf. Toegang hier.
- PlatoAiStream. Web3-intelligentie. Kennis versterkt. Toegang hier.
- PlatoESG. carbon, CleanTech, Energie, Milieu, Zonne, Afvalbeheer. Toegang hier.
- Plato Gezondheid. Intelligentie op het gebied van biotech en klinische proeven. Toegang hier.
- Bron: https://semiengineering.com/big-changes-ahead-for-photomask-technology/



