Chinas jüngster Erfolg eines Gießereiknotens der 7-nm-Klasse, der ausschließlich DUV-Lithographie verwendet [1], wirft die Frage auf, inwieweit die DUV-Lithographie durch Multipatterning erweitert werden kann. Eine aktuelle Veröffentlichung auf der CSTIC 2023 weist darauf hin, dass chinesische Gruppen derzeit eine Ausweitung der DUV-basierten Mehrfachmusterung auf 5 nm in Betracht ziehen und dabei sogar die Verwendung von 6 Masken für eine Schicht in Betracht ziehen [2]. Der Vergleich der DUV-basierten und EUV-basierten Ansätze in Richtung 3 nm führt zu einer interessanten Schlussfolgerung.
LELE-Musterung
Die grundlegendste Form der Mehrfachmusterung ist der sogenannte „Litho-Etch-Litho-Etch“-Ansatz (LELE), bei dem im Wesentlichen die grundlegende Lithographie durchgeführt und anschließend zweimal geätzt wird. Dies ermöglicht eine Halbierung der Teilung, da ein zweites Merkmal zwischen zwei gedruckten ersten Merkmalen eingefügt wird. Als Erweiterung könnten LE3 (3xLE) und LE4 (4xLE) folgen. Allerdings wird die Verwendung dieser Ansätze zum Erreichen von weniger als der Hälfte der ursprünglichen Tonhöhe nicht mehr bevorzugt, da selbstausrichtende Abstandsmuster auf den Markt kommen.
Selbstausrichtende Abstandsmuster
Die selbstausrichtende Abstandshalterstrukturierung hat gegenüber LELE den Vorteil, dass kein zusätzlicher Lithographieschritt erforderlich ist, wodurch zusätzliche Kosten eingespart werden. Abscheidung von Abstandshaltern und anschließendes Rückätzen, gefolgt von Lückenfüllung und anschließendem Rückätzen, Ersetzen der Schicht, Backen, Belichten, Backen, Entwickeln der Lithographiesequenz. Obwohl dies wesentlich kostengünstiger ist, ist dennoch eine präzise Prozesskontrolle erforderlich, beispielsweise hinsichtlich der Dicke des Abstandshalters und der Selektivität der Ätzrate. Eine einmalige Anwendung von Abstandshaltern führt zu einer Verdoppelung der Merkmale innerhalb einer bestimmten Teilung. Daher wird dies oft als selbstausrichtendes Doppelmuster (SADP) bezeichnet. Eine erneute Anwendung führt erwartungsgemäß zu einer selbstausgerichteten Vierfachstrukturierung (SAQP).
Subtraktive Musterung
Während sowohl LELE als auch SADP einem Muster auf natürliche Weise Features hinzufügen, ist es manchmal notwendig, Teile dieser Features für das endgültige Layout zu entfernen. Schnittmasken kennzeichnen Bereiche, in denen Liniensegmente entfernt werden sollen. Diese werden auch Blockstellen genannt, wenn die linienbildende Ätzung blockiert ist. Die inverse Maske wird Keep-Maske genannt. Das Beschränken eines Zeilenumbruchs auf eine einzelne Zeilenbreite führt zu Platzierungsproblemen, wenn die angrenzende Zeile ebenfalls geätzt werden kann. Wenn abwechselnde Linien so angeordnet werden können, dass sie aus unterschiedlichen zu ätzenden Materialien bestehen, können Linienunterbrechungen mit besseren Toleranzen vorgenommen werden (Abbildung 1).
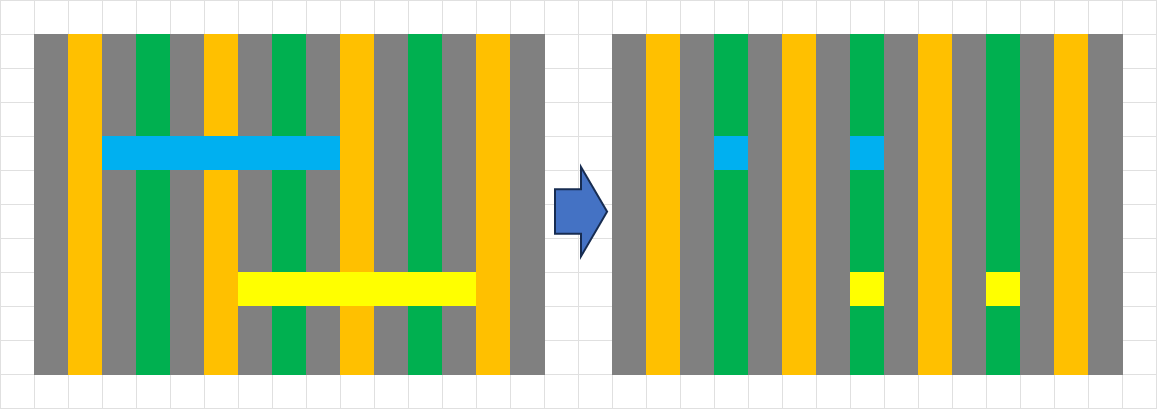
Abbildung 1. Selbstausrichtender Block/Schnitt entfernt nur Abschnitte alternativer Linien.
Für eine bestimmte Verbindungsleitung wird erwartet, dass der Abstand zwischen den Unterbrechungen mindestens zwei Metallteilungen beträgt. Daher werden zwei Masken pro Zeile erwartet, wenn der Metallabstand 1/4 bis 1/2 der Auflösungsgrenze beträgt.

Abbildung 2. Für die beiden Ätzsätze sind zwei Sätze Block-/Schnittmasken erforderlich.
Alternative Linienanordnung
Die Anordnung der alternativen Linien erfolgt auf natürliche Weise durch LELE, SADP, SAQP oder eine Mischung aus LELE und SADP, bekannt als SALELE (self-aligned LELE) [3]. SALELE wurde bereits als Standardanwendung für EUV für die engsten Metallabstände angesehen [2, 4].
DUV- vs. EUV-Kostenbewertung
Eine der Erwartungen für Multipatterning mit DUV waren die im Vergleich zu EUV steigenden Kosten. Es ist Zeit für eine aktualisierte Neubewertung. Zunächst verwenden wir die neuesten (2021) normalisierten Musterkostenschätzungen [5] (Abbildung 3).

Figur. 3 Normalisierte Kosten für die Musterung, aus Referenz 5.
Als nächstes verwenden wir repräsentative Musterstile für DUV und EUV für die verschiedenen Knoten (Abbildung 4).

Abbildung 4. DUV- vs. EUV-Strukturierungskosten vs. Knoten
Mehrere Kommentare sind angebracht:
- Bei 7-nm-DUV liegt der 40-nm-Abstand an einem Punkt, an dem die einzigen auflösbaren Merkmale Linien sind, sodass diese Linien in einer separaten Belichtung geschnitten werden müssen.
- Für 7-nm-EUV wird ein separater Linienschnitt verwendet, da bei einem Abstand von 40 nm die erforderliche Auflösung (~20 nm) geringer ist als die Punktspreizfunktion des EUV-Systems (~25 nm). Ein EUV-System mit hoher NA ist für diese Tonhöhe ebenfalls nicht vorteilhaft, da die Tiefenschärfe und die Pupillenfüllung begrenzt sind [6].
- Für 3/5 nm DUV ist LELE SADP flexibler als SAQP für einen Pitch unter 40 nm [7].
- Für 3/5 nm EUV ist die treibende Kraft bei der Verwendung von LELE das stochastische Verhalten bei <17 nm Halbabstand und <20 nm isolierter Linienbreite [8,9]. Wenn wir uns den Dimensionen von 10 nm nähern, wird auch die dosisabhängige Unschärfe der Elektronenstreuung [10-12] unerschwinglich. Die optische Auflösung des Systems, also NA, ist nicht mehr relevant.
- Die Musterformung wird nicht als eine Möglichkeit betrachtet, Schnitte zu vermeiden, da sie die Lithographie vor der Formung erheblich erschweren würde (Abbildung 5). Außerdem wurde das Ätzen mit einem abgewinkelten Ionenstrahl im Allgemeinen verwendet, um eine bereits vorhandene Topographie zu glätten und so die Höhe der Ätzmaske zu verringern [13].

Abbildung 5. Bei der Musterformung ist das Muster vor der Formung sehr unfreundlich für die Steinbearbeitung.
Im Großen und Ganzen können wir das direkte Urteil fällen, dass DUV-LELE viel günstiger ist als EUV-Einzelbelichtung (SE). Außerdem ist DUV LE4 günstiger als EUV-Doppelmusterung. Obwohl LELE im Vergleich zu SE zusätzliche Schritte erfordert, müssen auch die EUV-Systemwartung im Vergleich zur DUV-Systemwartung sowie der Energieverbrauch berücksichtigt werden. DUV LELE verbraucht halb so viel Energie wie EUV SE, DUV SADP etwa 2/3 und sogar DUV LE4 verbraucht knapp 85 % der Energie für EUV SE [14].
All dies verdeutlicht, dass die Umstellung auf fortgeschrittene Knoten mit steigenden Kosten verbunden ist, unabhängig von der Wahl von DUV oder EUV.
Bibliographie
[1] https://www.techinsights.com/blog/techinsights-finds-smic-7nm-n2-huawei-mate-60-pro
[2] Q. Wu et al., CSTIC 2023.
[3] Y. Drissi et al., Proc. SPIE 10962, 109620V (2019).
[4] R. Venkatesan et al., Proc. SPIE 12292, 1229202 (2022).
[5] S. Snyder et al., EUVL-Workshop 2021, https://www.euvlitho.com/2021/P2.pdf
[6] F. Chen, When High NA is Not Better Than Low NA in EUV Lithography, 2023, https://www.youtube.com/watch?v=10K5i4QdLBU
[7] S. Sakhare et al., Proc. SPIE 9427, 94270O (2015).
[8] L. Meli et al., J. Micro/Nanolith. MEMS MOEMS 18, 011006 (2019).
[9] D. De Simone und G. Vandenberghe, Proc. SPIE 10957, 109570Q (2019).
[10] A. Narasimhan et al., Proc. SPIE 9422, 942208 (2015).
[11] I. Bespalov et al., ACS Appl. Mater. Schnittstellen 12, 9881 (2020).
[12] F. Chen, Modellierung stochastischer EUV-Defekte mit Sekundärelektronenunschärfe, https://www.linkedin.com/pulse/modeling-euv-stochastic-defects-secondary-electron-blur-chen
[13] M. Ulitschka et al., J. Europ. Opt. Soc. – Rapid Pub. 17:1 (2021).
[14] LA. Ragnarsson et al., 2022 Electron Dev. Technik. Manufaktur, 82 (2022).
Dieser Artikel erschien zuerst in LinkedIn Pulse: Erweiterung des DUV-Multipatternings in Richtung 3 nm
Lesen Sie auch:
Stochastisches Modell für die Säurediffusion in chemisch verstärkten DUV-Resists
Weiterentwicklung von Halbleiterprozessen mit neuartigen Extrem-UV-Fotoresistmaterialien
Modellierung stochastischer EUV-Defekte mit Sekundärelektronenunschärfe
Teile diesen Beitrag über:
- SEO-gestützte Content- und PR-Distribution. Holen Sie sich noch heute Verstärkung.
- PlatoData.Network Vertikale generative KI. Motiviere dich selbst. Hier zugreifen.
- PlatoAiStream. Web3-Intelligenz. Wissen verstärkt. Hier zugreifen.
- PlatoESG. Kohlenstoff, CleanTech, Energie, Umwelt, Solar, Abfallwirtschaft. Hier zugreifen.
- PlatoHealth. Informationen zu Biotechnologie und klinischen Studien. Hier zugreifen.
- Quelle: https://semiwiki.com/lithography/336182-extension-of-duv-multipatterning-toward-3nm/



