Extrem-Ultraviolett-Lithographiesysteme (EUV) sind die fortschrittlichsten Lithographiesysteme, die heute im Einsatz sind. Dieser Artikel ist eine grundlegende Einführung in diese wichtige, aber komplexe Technologie.
Das Ziel: Eine kleinere Wellenlänge
Die Einführung der Wellenlänge von 13.5 nm setzt einen Trend fort, den die Halbleiterindustrie seit der Verwendung von blauem Licht (436 nm „g-Linie“-Wellenlänge) für Strukturgrößen > 1 Mikrometer einer Reduzierung der Wellenlänge folgt. Das Licht wird durch eine Maske (oder „Fadenkreuz“) projiziert, auf der das Schaltkreismuster aufgedruckt ist. Das übertragene Bild wird dann verkleinert, wenn es schließlich auf den Wafer projiziert wird. Der Mindestabstand beträgt die Hälfte der Wellenlänge dividiert durch die numerische Apertur (NA) des Systems. Die NA eines optischen Systems ist eine dimensionslose Zahl, die den Winkelbereich angibt, über den die endgültige Linse Licht fokussieren kann. Die Wellenlängenreduzierung ist nicht trivial, da dadurch die Energie der Photonen umgekehrt proportional erhöht wird. Folglich ist die Absorption in allen Materialien hoch. Daher werden vollständig reflektierende außeraxiale optische Systeme benötigt. Dies hat zur Entwicklung sogenannter „Ringfeld“-Projektionssysteme geführt, die zu einer Rotation der Beleuchtung über das Belichtungsfeld führen [1]. Optische Systeme vor EUV konnten auf achsentransmissiven Optiken basieren, was den Beleuchtungsaufbau vereinfachte, da es keine Rotation gab.
Eine andere Maske
Die Verwendung der EUV-Wellenlänge führte auch zu einer Überarbeitung der Maskenstruktur. Die Maske ist auch ein reflektierendes Element. Die Reflexion wird mit einem Multilayer bestehend aus mindestens 40 Molybdän/Silizium-Doppelschichten erreicht. Das Maskenmuster verwendet eine absorbierende Schicht, derzeit auf Tantalbasis, die mehrere Wellenlängen dick ist. Da die außeraxiale Beleuchtung durch das Absorbermuster gestreut wird und sich durch die Mehrschicht ausbreitet und reflektiert, sind 3D-Effekte unvermeidlich, die das endgültige Bild auf dem Wafer beeinflussen [2].
Die Maske wird außerdem durch eine dünne Membran namens Pellikel geschützt, die in einem gewissen Abstand von der Maskenoberfläche absteht. Die Entwicklung eines Pellikels für EUV war eine große Sache, da Licht als nicht reflektierendes Übertragungselement zweimal durch dieses hindurchgehen muss.
Ändern der numerischen Apertur
Die numerische Apertur in aktuellen EUV-Systemen beträgt 0.33. In einer zukünftigen Generation von EUV-Systemen wird die numerische Apertur auf 0.55 erhöht. Es wird erwartet, dass dies aufgrund der Wellenlänge/NA-Proportionalität 0.6-mal kleinere Strukturgrößen ermöglicht. Es ist jedoch zu erwarten, dass die Schärfentiefe dadurch beeinträchtigt wird, dass sie schneller abnimmt als die Auflösung, da sie ungefähr proportional zur Wellenlänge/(NA)^2 ist (Abbildung 1) [3]. Für 0.55 NA EUV hat dies zu Bedenken hinsichtlich der Verwendung von Resist (der absorbierenden Bildschicht auf dem Wafer) mit einer Dicke von nur 20 nm geführt [4].

Ein 0.55 NA-System bringt zusätzliche Komplikationen mit sich. Erstens handelt es sich um ein Halbfeldsystem, was bedeutet, dass zwei Maskenscans erforderlich sind, um denselben Bereich auszufüllen wie ein einzelner Maskenscan in einem früheren System [5]. Zweitens gibt es eine zentrale Verdunkelung, die durch die letzten beiden optischen Elemente projiziert wird. Dies schränkt die Beleuchtung sowie bestimmte Tonhöhenkombinationen ein [6]. Schließlich wird die Polarisation für Tonhöhen wichtig, die 0.55 NA nutzen können [7].
Die Verschleierung ist der grundlegende systematische Unterschied, der sich auf die projizierte Skalierung gegenüber den aktuellen 0.33-NA-Systemen auswirkt. Kurz vor Erreichen des letzten Fokussierungselements kommt es zu Lichtverlust. Darüber hinaus wird sich die Bildqualität grundlegend ändern. Schlüsselkomponenten des Bildbeugungsspektrums. Abbildung 2 zeigt eine helle Linie mit einem Abstand von 68 nm unter Beleuchtung, die auf einen Abstand von 28 nm zugeschnitten ist. Das Erscheinungsbild ist ohne Verdunkelung normal, aber wenn die Verdunkelung vorhanden ist, wird der zentrale Peak abgeschwächt und die Nebenkeulen daneben verstärkt, da die erste Beugungsordnung entfernt wird. Diese Nebenkeulen können stochastisch drucken [8].
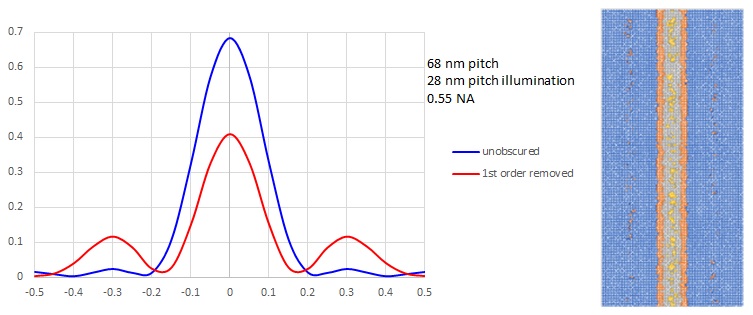
Es ist nicht nur das EUV-Licht ...
Leider ist die EUV-Lithographie mit einer Reihe von Faktoren behaftet, die bei der bisher betrachteten klassischen optischen Behandlung nicht offensichtlich sind. Das EUV-Licht ist eine Form ionisierender Strahlung, das heißt, es setzt bei Absorption Elektronen im Lack frei. Die Photoelektronen (~80 eV) stammen aus der direkten Ionisierung, und die Sekundärelektronen stammen aus der dadurch verursachten Ionisierung und den anschließend freigesetzten Elektronen. Die durch die Elektronenstreuung deponierte Energie erhitzt offensichtlich den Lack, was zu einer Ausgasung führt, die die optischen Elemente im EUV-System verunreinigt. Aus diesem Grund enthalten EUV-Systeme jetzt eine minimal absorbierende Wasserstoffumgebung, die die Oberflächen der optischen Elemente sauber hält, ohne sie zu oxidieren. Es ist jedoch bekannt, dass Wasserstoff auch Blasenbildung verursacht [9].
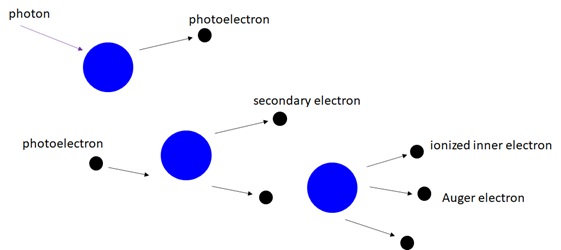
Die Elektronen breiten sich auch von der ursprünglichen Photonenabsorptionsstelle aus, was dazu führt, dass das ursprünglich definierte Bild unscharf wird. Die Auswirkungen dieser Unschärfe sind bereits mehrere Nanometer entfernt spürbar. Der Ausbreitungseffekt wird durch die inhärente Zufälligkeit der gesamten Ereigniskette noch verstärkt.
EUV enthüllt die stochastische Natur der Lithographie
Photonenabsorption und Elektronenstreuung sind allesamt von Natur aus zufällige Ereignisse. Diese führen zu CD-Ungleichmäßigkeiten und Kantenrauheiten und sogar zu Platzierungsfehlern und schwerwiegenden Defekten. Stochastische Effekte sind bei geringerer absorbierter Photonendichte schwerwiegender. Dünnere Resists reduzieren die Absorption und verstärken diesen Effekt. Eine erhöhte Photonendichte führt jedoch zu einer erhöhten Elektronenzahldichte und einer erhöhten Elektronenunschärfe, deren Zufälligkeit zu stochastischen Defekten führt [10]. Die DUV-Lithographie hatte sich nicht mit stochastischen Problemen befasst, hauptsächlich weil die Strukturgrößen groß genug waren, um genügend Photonen zu sichern, aber EUV konnte diesen Vorteil nicht nutzen.
Bibliographie
- Antoni et al., Proc. SPIE 4146, 25 (2000).
- Tanabe, Proc. SPIE 11854, 1185416 (2021).
- J. Lin, J. Micro/Nanolith., MEMS und MOEMS 1, (2002).
- https://www.imec-int.com/en/articles/high-na-euvl-next-major-step-lithography
- Davydova et al., Proc. SPIE 12494, 124940Q (2023).
- https://www.youtube.com/watch?v=1HV2UYABh4E
- https://www.youtube.com/watch?v=agMx-nuL_Qg
- https://www.youtube.com/watch?v=sb46abCx5ZY
- https://www.youtube.com/watch?v=FZxzwhBR5Bk&t=3s
- https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen
Lesen Sie auch:
SPIE 2023 – imec bereitet sich auf High-NA EUV vor
Curvilinear Mask Patterning zur Maximierung der Lithographiefähigkeit
Realitätsprüfungen für EUV mit hoher NA für 1.x-nm-Knoten
Teile diesen Beitrag über:
- SEO-gestützte Content- und PR-Distribution. Holen Sie sich noch heute Verstärkung.
- PlatoAiStream. Web3-Datenintelligenz. Wissen verstärkt. Hier zugreifen.
- Die Zukunft prägen mit Adryenn Ashley. Hier zugreifen.
- Kaufen und verkaufen Sie Anteile an PRE-IPO-Unternehmen mit PREIPO®. Hier zugreifen.
- Quelle: https://semiwiki.com/lithography/329464-a-primer-on-euv-lithography/



