Aşırı ultraviyole (EUV) litografi sistemleri, günümüzde kullanılan en gelişmiş litografi sistemleridir. Bu makale, bu önemli ancak karmaşık teknoloji hakkında temel bir başlangıç niteliğindedir.
Hedef: Daha Küçük Bir Dalga Boyu
13.5 nm dalga boyunun tanıtılması, yarı iletken endüstrisinin, > 436 mikron özellik boyutları için mavi ışığın (1 nm "g-line" dalga boyu) kullanılmasından bu yana dalga boyu azaltmasını takip ettiği bir trendi sürdürüyor. Işık, üzerinde devre deseni basılı olan bir maske (veya "retikül") aracılığıyla yansıtılır. İletilen görüntü daha sonra gofretin üzerine yansıtıldığında küçültülür. Minimum perde, sistemin sayısal açıklığına (NA) bölünen dalga boyunun yarısıdır. Bir optik sistemin NA'sı son merceğin ışığı odaklayabileceği açı aralığını gösteren boyutsuz bir sayı. Fotonların enerjisinin ters orantılı olarak artması anlamına geldiğinden, dalga boyu azalması önemsiz değildir. Sonuç olarak, tüm malzemelerde yüksek absorpsiyon vardır. Bu nedenle, tamamen yansıtıcı eksen dışı optik sistemlere ihtiyaç vardır. Bu, aydınlatmanın pozlama alanı boyunca döndürülmesine yol açan "halka alan" projeksiyon sistemlerinin geliştirilmesine yol açmıştır [1]. EUV öncesi optik sistemler, dönüşsüz olarak aydınlatma kurulumunu basitleştiren eksen üstü aktarıcı optiğe güvenebilirdi.
Farklı Bir Maske
EUV dalga boyunun kullanılması ayrıca maske yapısının elden geçirilmesine de yol açtı. Maske aynı zamanda yansıtıcı bir unsurdur. Yansıma, en az 40 molibden/silikon çift katmandan oluşan bir çok katmanla sağlanır. Maske deseni, şu anda birkaç dalga boyu kalınlığında olan tantala dayalı bir emici katman kullanır. Emici model boyunca saçılan ve çok katmanlı boyunca yayılan ve yansıtan eksen dışı aydınlatma ile, gofret üzerindeki nihai görüntüyü etkilemede 3D efektleri kaçınılmazdır [2].
Maske ayrıca, maske yüzeyinden belirli bir mesafede duran zar adı verilen ince bir zarla korunur. EUV için bir zar geliştirmek çok önemliydi, çünkü ışığın yansıtmayan bir iletici eleman olarak içinden iki kez geçmesi gerekiyor.
Sayısal Açıklığı Değiştirme
Mevcut EUV sistemlerindeki sayısal açıklık 0.33'tür. Gelecek nesil EUV sistemlerinde, sayısal açıklık 0.55'e yükseltilecektir. Bunun, dalga boyu/NA orantılılığından 0.6 kat daha küçük özellik boyutlarını etkinleştirmesi bekleniyor. Bununla birlikte, kabaca dalga boyu/(NA)^2 ile orantılı olduğundan, odak derinliğinin çözünürlükten daha hızlı düşürülerek zarar görmesi beklenir (Şekil 1) [3]. 0.55 NA EUV için bu, 20 nm [4] kadar ince olan resist (gofret üzerindeki emici görüntü katmanı) kullanımıyla ilgili endişelere yol açmıştır.

0.55 NA sisteminin ek komplikasyonları vardır. Birincisi, yarım alan sistemidir, yani daha önceki bir sistemde tek maske taramasıyla aynı alanı doldurmak için iki maske taraması gerekir [5]. İkinci olarak, son iki optik öğe tarafından yansıtılan merkezi bir karartma vardır. Bu, aydınlatmayı ve belirli perde kombinasyonlarını kısıtlar [6]. Son olarak, polarizasyon, 0.55 NA kullanabilen perdeler için önemli hale gelir [7].
Karartma, mevcut 0.33 NA sistemlerinden öngörülen ölçeklendirmeyi etkileyen temel sistematik farktır. Nihai odaklama elemanına ulaşmadan hemen önce ışık kaybı olacaktır. Ek olarak, görüntü kalitesi temelden değişecektir. Görüntü kırınım spektrumunun temel bileşenleri. Şekil 2, 68 nm aralık için uyarlanmış aydınlatma altında 28 nm aralıklı parlak bir çizgiyi göstermektedir. Görünüş, karartma olmadan normaldir, ancak karartma yerinde olduğunda, ilk kırınım sırası kaldırıldığı için merkezi tepe azalır ve yanındaki yan loblar artar. Bu yan loblar stokastik olarak yazdırılabilir [8].
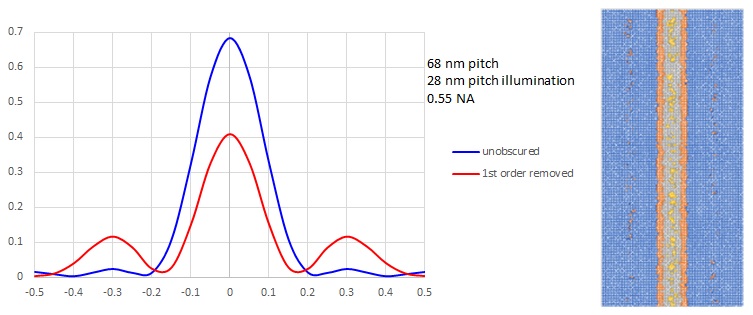
Sadece EUV Işığı Değil…
EUV litografi, ne yazık ki, şu ana kadar ele alınan klasik optik işlemden bariz olmayan bir dizi faktörle boğuşuyor. EUV ışığı, bir iyonlaştırıcı radyasyon biçimidir, yani absorpsiyon üzerine dirençte elektronları serbest bırakır. Fotoelektronlar (~80 eV) doğrudan iyonlaşmadan ve ikincil elektronlar bunların neden olduğu iyonlaşmadan ve daha sonra salınan elektronlardandır. Elektron saçılmasıyla biriken enerji, direnci açık bir şekilde ısıtacak ve EUV sistemindeki optik elemanları kirletecek olan gaz çıkışına yol açacaktır. Bu nedenle, EUV sistemleri artık optik elemanların yüzeylerini oksitlemeden temiz tutacak, minimum düzeyde soğuran bir hidrojen ortamı içerir. Bununla birlikte, hidrojenin ayrıca kabarmaya da neden olduğu bilinmektedir [9].
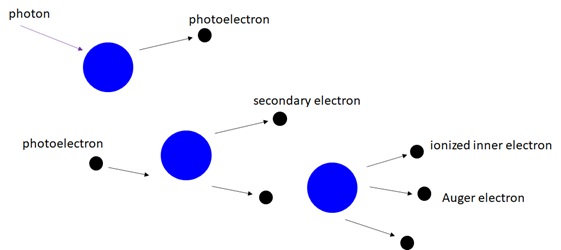
Elektronlar ayrıca orijinal foton absorpsiyon bölgesinden yayılarak orijinal olarak tanımlanmış görüntünün bulanık olmasına yol açar. Bu bulanıklığın etkileri birkaç nanometre öteden kolayca hissedilir. Yayılma etkisini daha da ağırlaştıran şey, tüm olaylar zincirinin doğasında var olan rastlantısallıktır.
EUV, Litografinin Stokastik Doğasını Ortaya Çıkarıyor
Foton absorpsiyonu ve elektron saçılması, doğası gereği rastgele olaylardır. Bunlar, CD düzensizliğine ve kenar pürüzlülüğüne ve hatta yerleştirme hatalarına ve ciddi kusurlara yol açar. Stokastik etkiler, daha düşük soğurulan foton yoğunluğu ile daha ciddidir. Tiner dirençleri emilimi azaltır ve bu etkiyi arttırır. Bununla birlikte, artan foton yoğunluğu, artan elektron sayısı yoğunluğuna ve artan elektron bulanıklığına yol açar, bu da rastgeleliği stokastik kusurlara yol açar [10]. DUV litografisi stokastik sorunları ele almamıştı çünkü özellik boyutları yeterli fotonları güvence altına alacak kadar büyüktü, ancak EUV bu avantajdan yararlanamadı.
Referanslar
- Antoni ve diğ., Proc. SPIE 4146, 25 (2000).
- Tanabe, Proc. SPIE 11854, 1185416 (2021).
- J. Lin, J. Micro/Nanolith., MEMS ve MOEMS 1, (2002).
- https://www.imec-int.com/en/articles/high-na-euvl-next-major-step-lithography
- Davydova ve diğ., Proc. SPIE 12494, 124940Q (2023).
- https://www.youtube.com/watch?v=1HV2UYABh4E
- https://www.youtube.com/watch?v=agMx-nuL_Qg
- https://www.youtube.com/watch?v=sb46abCx5ZY
- https://www.youtube.com/watch?v=FZxzwhBR5Bk&t=3s
- https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen
Ayrıca Oku:
SPIE 2023 – imec Yüksek NA EUV'ye Hazırlanıyor
Litografi Kapasitesini En Üst Düzeye Çıkarmak için Eğrisel Maske Modelleme
1.x nm Düğümleri için Yüksek NA EUV için Gerçeklik Kontrolleri
Bu gönderiyi şu yolla paylaş:
- SEO Destekli İçerik ve Halkla İlişkiler Dağıtımı. Bugün Gücünüzü Artırın.
- PlatoAiStream. Web3 Veri Zekası. Bilgi Genişletildi. Buradan Erişin.
- Adryenn Ashley ile Geleceği Basmak. Buradan Erişin.
- PREIPO® ile PRE-IPO Şirketlerinde Hisse Al ve Sat. Buradan Erişin.
- Kaynak: https://semiwiki.com/lithography/329464-a-primer-on-euv-lithography/



