SPIE Gelişmiş Litografi Konferansı Şubat ayında gerçekleştirildi. Geçenlerde imec'te ileri modelleme süreci ve malzemelerinden sorumlu başkan yardımcısı Steven Scheer ile röportaj yapma ve imec'in sunduğu seçilmiş makaleleri gözden geçirme fırsatım oldu.
Steve'e bu yıl SPIE'deki kapsayıcı mesajın ne olduğunu sordum, Yüksek NA'ya hazır olmanın anahtar olduğunu söyledi. Üç temel ekosistem alanı belirledi:
- Maske ve Çözünürlük Geliştirme Teknolojisi (RET) altyapısı.
- Malzemeler, fotorezist ve alt katmanlar.
- Metroloji
Teşhir araçları da elbette anahtardır, ancak Steve'in bahsettiği şey bu değil. Yazarların notu – ASML'nin SPIE sunumları hakkında da bir yazı yazacağım.
Maskeler
Steve, maskeyle ilgili sorunları listelemeye devam etti:
- Odak kayması ve kontrast kaybı gibi 3 boyutlu efektleri maskeleyin – Yüksek NA, 3 boyutlu efektleri daha önemli hale getiren düşük açılı bir pozlamadır.
- Düşük kusurlu maske boşlukları ve pürüzlülük ve CD'de düşük değişkenliğe sahip maskeler
- Düşük n maskeleri, daha yüksek kontrast sağlamak ve 3D efektlerini maskelemek için gereklidir.
- Optik Yakınlık Düzeltme teknikleri.
- Maske yazma, çok ışınlı.
- Maske dikişi – tarayıcı alanının daha küçük boyutu, kalıbın birbirine dikilmesini gerektirir.
- 4x tek yön, 8x diğer yön, dikişi etkinleştirmek için yeni tipte bir maske tasarımı gerektirir.
- Daha yüksek kaynak enerjisi için peliküller.
In "CNT zarları: Son optimizasyon ve teşhir sonuçları" Joost Bekaert ve diğerleri, Karbon Nanotüp zarlarını (CNT) araştırdı.
ASML'nin yol haritasında 600 watt'lık kaynak sistemleri var, metal silisite dayalı mevcut zarlar yalnızca yaklaşık 400 watt'a kadar geçerli. Peliküllerin partikülleri bloke etmesi, yüksek geçirgenliğe sahip olması, yaklaşık 110 mm'ye 140 mm'lik bir alanda asılı kalmak için yeterli mekanik güce sahip olması ve dayanıklı olması gerekir. CNT %98'e varan iletim göstermiştir. EUV radyasyonu o kadar enerjiktir ki zar zarını aşındıran ve sonunda zar zarının mekanik bütünlüğünün kaybına yol açan bir hidrojen plazması oluşturur. imec, aşındırma oranlarını ve zarın nasıl stabilize edileceğini değerlendiriyor.
Aşındırma oranları iletime bakılarak değerlendirilebilir, Pelikül dağlama ile inceltildiği için iletim artar. Şekil 1, çeşitli koşullara tabi bir Pellicle'ın zaman içindeki iletimini göstermektedir.
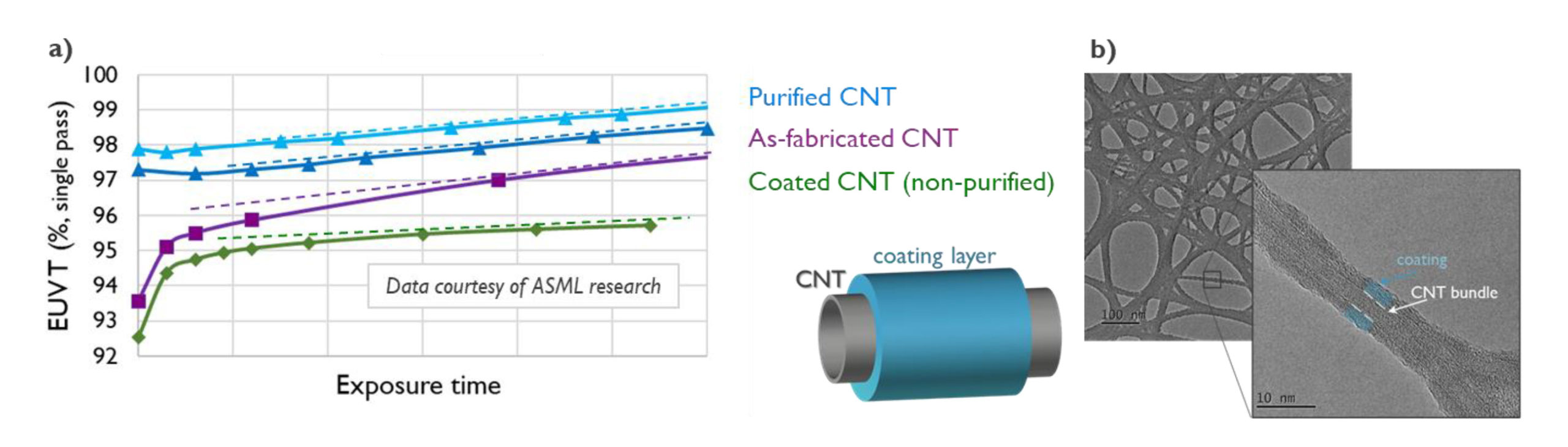
ASML, çevrimdışı bir plazma maruz bırakma aracını kullanarak zar iletimine maruz kalma süresine karşı değerlendirme yapar ve bu çalışmada imec, 3,000 gofrete kadar CNT zar maruziyetini gösterdi (96 kalıp, gofret başına 30 mJ/cm²'de XNUMX kalıp) ve gerçek tarayıcı maruziyetinden elde edilen sonuçlar arasında korelasyon gösterdi ve çevrimdışı araçtan gelenler.
Peliküller başlangıçta, yanana kadar EUV enerjisini emen üretim sürecinden kaynaklanan uçucu organik safsızlıklara sahiptir, yeşil ve mor eğrilere bakın. Pelikülün yüksek sıcaklıklarda pişirilmesi, aşındırma hızının baskın olduğu iletim değişikliklerine yol açan kirleticileri yakarak zarcığı "saflaştırır". İki mavi eğrinin eğimi asitleme hızından kaynaklanmaktadır. Yeşil eğri, daha düşük aşındırma oranı sergileyen "kaplanmış" bir zarı göstermektedir, ancak kaplama iletimi azaltır ve çok yüksek güç seviyeleriyle uyumlu olmayabilir.
Foto dirençli
Steve, daha sonra fotorezisti tartıştı.
Fotodirenç için 24nm ila 20nm perde, en yüksek çözünürlük olan 16nm perde ile Yüksek NA ekleme için tatlı bir noktadır. Chemically Amplified Resist (CAR) 24 nm'nin altında zayıf performansa sahiptir. Metal Oksit Dirençleri (MOR), 17 nm'ye ve hatta 16 nm'ye kadar ümit verici görünüyor. Kusurluluk hala bir sorundur. 24nm aralıktaki dozlar 67mJ/cm'dir2 MOR ve 77mJ/cm için2 araba için. MOR'un bazı kararlılık sorunları vardır ve doz ne kadar düşükse direnç o kadar reaktif/daha az kararlıdır. Bunlar meydan okumalar, şovmenler değil.
In “EUV litografi için küçültülmüş birikmiş alt katmanlar” Gupta ve diğerleri, fotorezist alt tabakaları araştırdı. Perde küçüldükçe, aynı fotorezist katman için en boy oranı artar ve modelin çökmesine neden olabilir. Geliştirilmiş alt katman yapışması bu sorunu çözebilir. Alternatif olarak, en-boy oranını yönetmek için daha ince bir fotodirenç kullanılabilir, ancak bu, katman altında yüksek bir aşındırma seçiciliği bulunamadığı sürece aşındırma sorunlarına yol açabilir.
imec, iyileştirilmiş yapışma elde etmek için uygulanan alt katmanların yüzey enerjisinin fotodirençle eşleştirilebileceğini buldu. Geliştirilmiş aşındırma seçiciliği sağlamak için biriktirilen alt katmanın yoğunluk ayarı kullanılabilir.
In “Yüksek NA EUV Litografiye Doğru Kuru Dirençli Modelleme Hazırlığı” imec ve Lam'den Hyo Sean Suh ve diğerleri, Lam'in kuru fotodirenç sürecini araştırdı. N2+ ve A14 prosesleri için Metal 2 hatvesinin (M2P) 24nm uçtan uca (T15T) ile ~2nm olması ve ardından A10'da M2P'nin <22nm T15T ile ~2nm olması bekleniyor.
Lam kuru direnç süreci şekil 2'de gösterilmektedir.
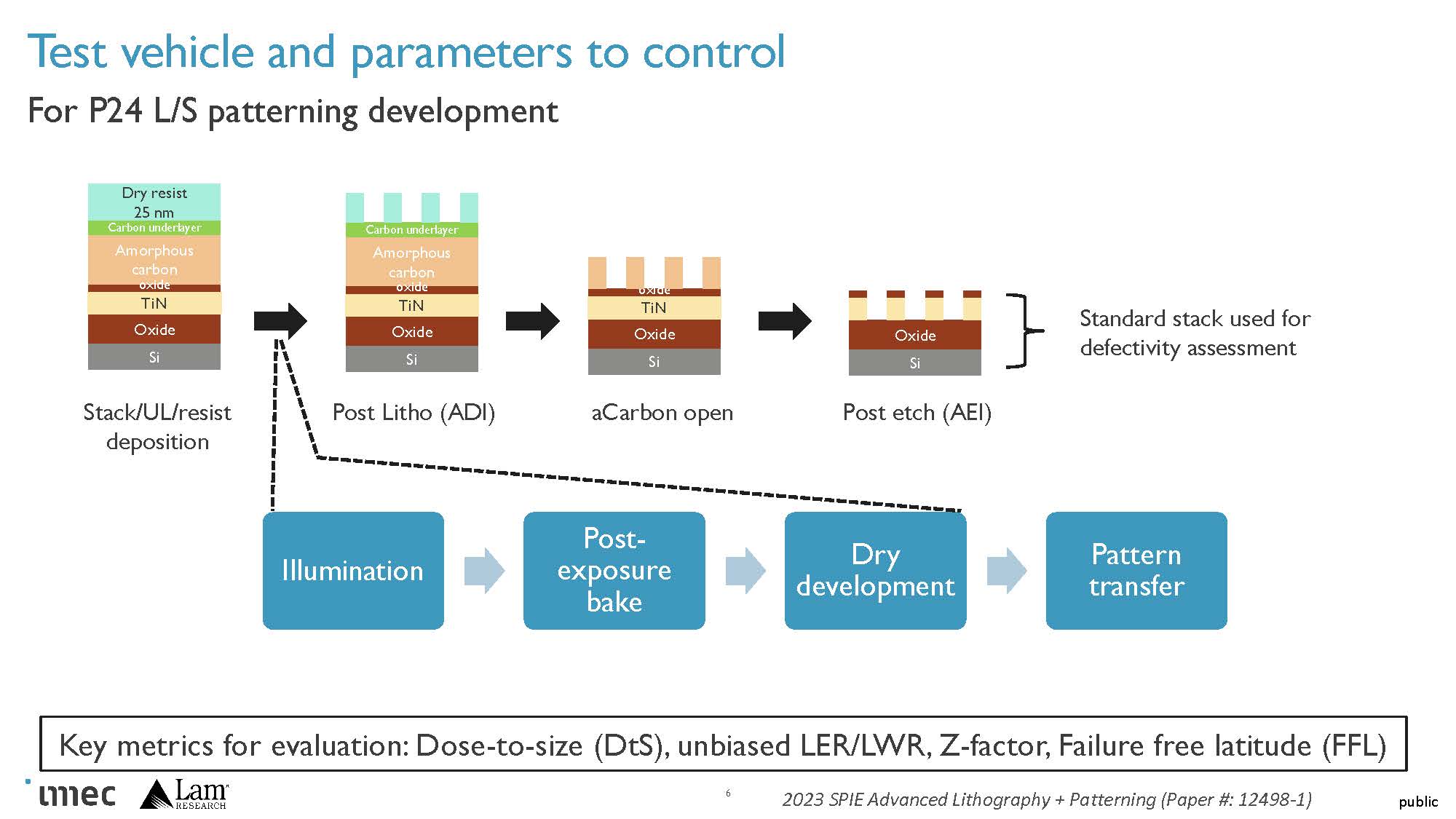
Pozlama Sonrası Pişirmenin (PEB) doz azaltımını güçlü bir şekilde sağladığı, ancak köprüleri ve pürüzlülüğü etkilediği bulundu. Geliştirme ve asitlemeyi birlikte optimize etme, köprüleri ve pürüzlülüğü azaltır ve 24nm adımlı L/S modelleme için sağlam bir süreç penceresi gösterir.
In “0.55NA EUV tek modelleme ile mantıksal metal ölçeklemenin uygulanabilirliği” Dongbo Xu ve ark. High-NA (0.55NA) sisteminin tek desenleme ile neler başarabileceğinin bir değerlendirmesini açıkladı.
24nm aralığının ulaşılabilir göründüğü sonucuna vardılar. 20nm yatay yönde ümit verici görünüyor, ancak dikey yönde daha fazla çalışma gerekiyor. 18nm zift ek çalışma gerektirir.
EUV, Çizgi pürüzlülüğü ve stokastik kusur açısından çok zorlu bir teknoloji olduğunu kanıtladı. Yönlendirilmiş Kendi Kendine Montaj (DSA), uzun süredir var olan ancak fazla ilgi görmeyen bir teknolojidir. DSA artık EUV için hat pürüzlülüğünü ve stokastik kusurları ele alan bir teknik olarak dikkat çekiyor.
In “BLOK KOPOLİMER YÖNLENDİRMELİ KENDİNDEN MONTAJ KULLANARAK EUV LİTOGRAFİ ÇİZGİ BOŞLUK DESENİNİN DÜZELTİLMESİ: Bir pürüzlülük ve kusurluluk çalışması,” Julie Van Bel ve ark. DSA'yı EUV ile birleştirmenin, daha düşük çizgi genişliği pürüzlülüğü ve dislokasyon hatası olmayan Daldırma litografiye dayalı DSA işlemlerinden üstün olduğunu buldu.
In “Yönlendirilmiş Kendinden Montajla EUV Litografide Stokastikleri Azaltma” Lander Verstraete ve ark. EUV işlemedeki stokastik kusurları azaltmak için DSA kullanılarak araştırıldı.
Çizgi/boşluk EUV kusurlarını düzeltmek için imec süreci şekil 3'te gösterilmektedir.
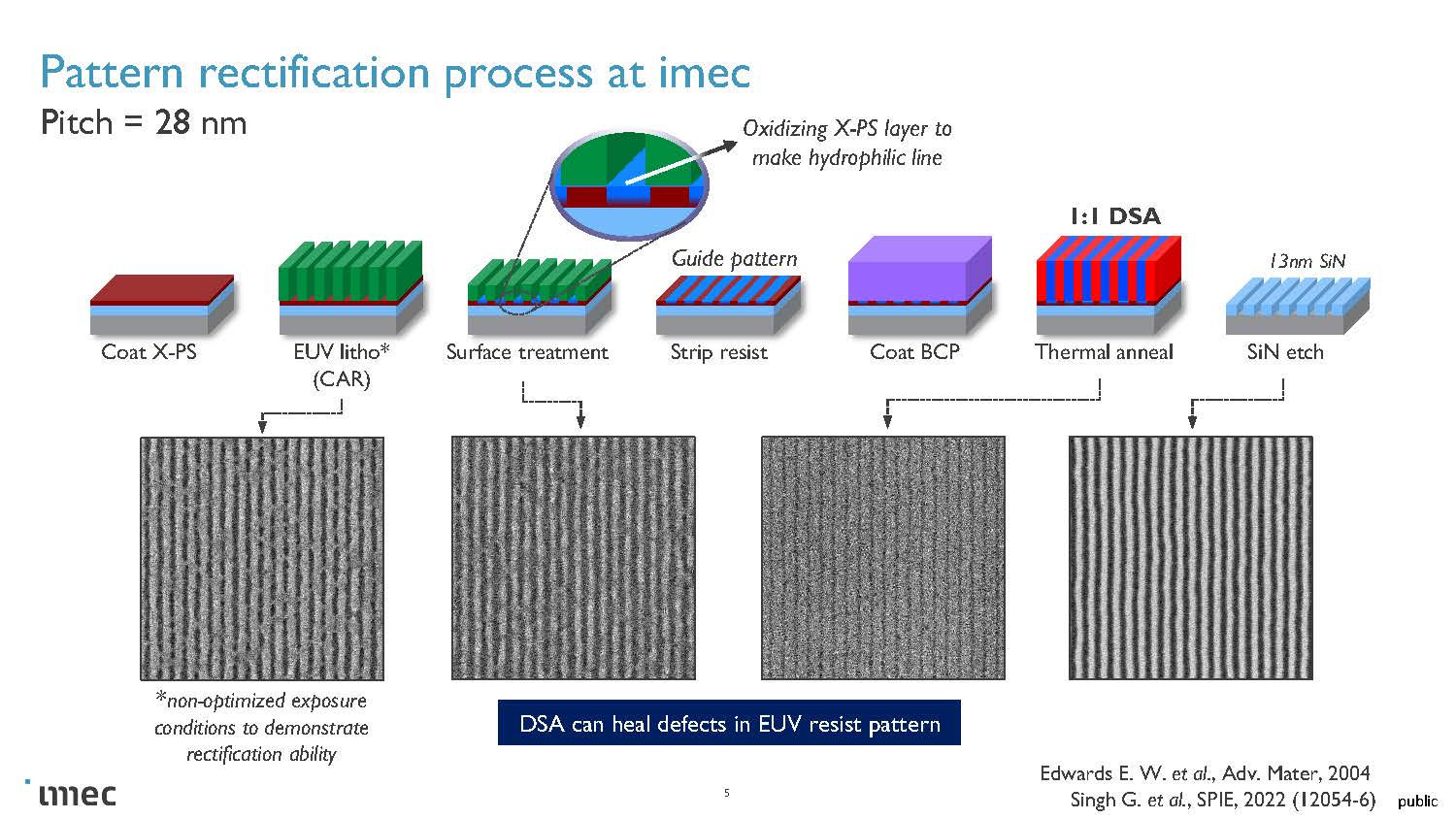
Temas dizilerindeki kusurları düzeltmek için imec süreci şekil 4'te gösterilmektedir.
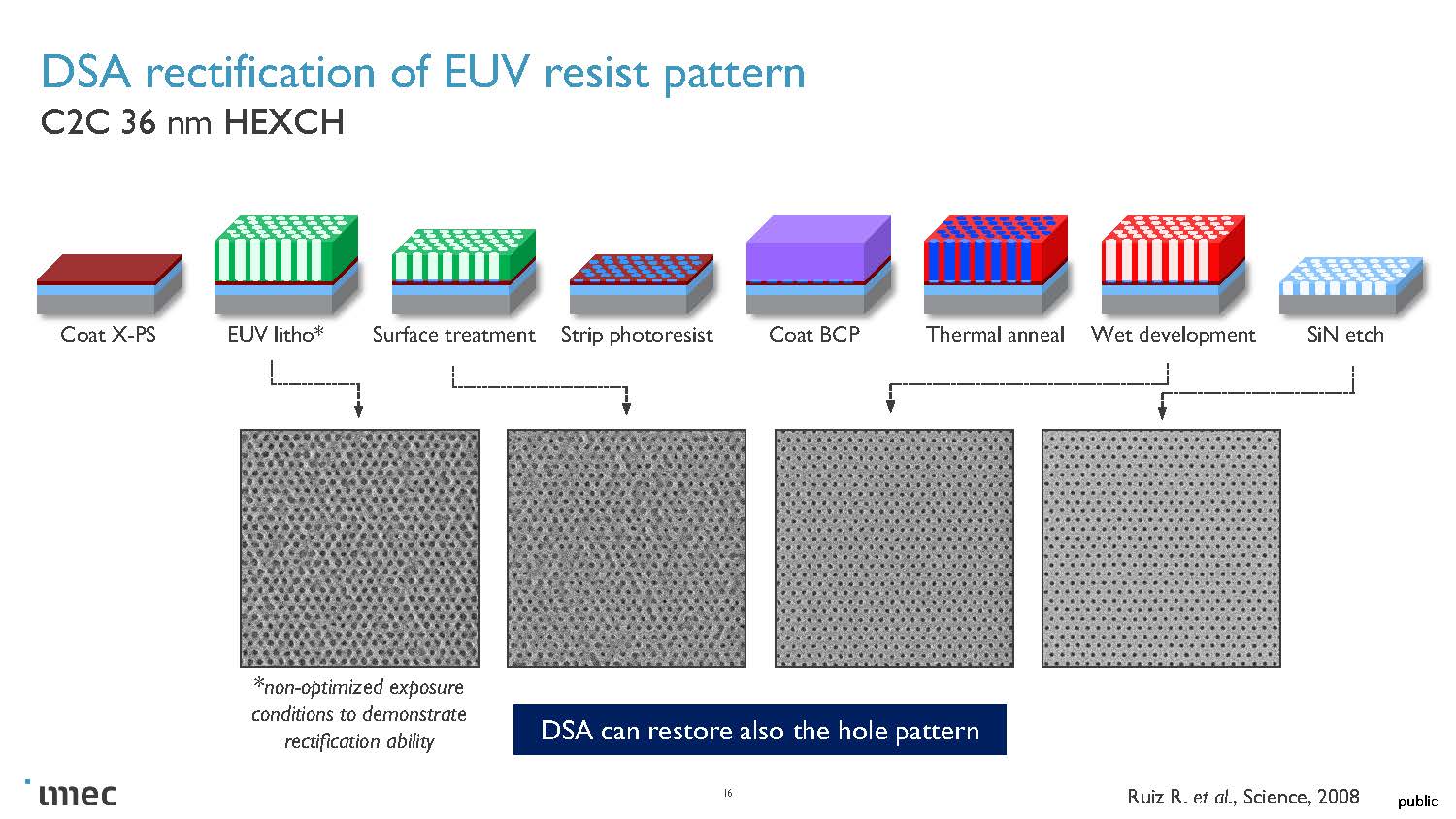
EUV plus DSA, 28nm perdede hat/boşluklar için çok umut verici görünüyor ve birincil kusur köprüler. 24nm perdede, çok fazla köprü kusuru ile iyileştirme gereklidir. Kusurlar, blok kopolimer formülasyonu ve tavlama süresi ile ilişkilidir.
Kontak dizileri için EUV + DSA, Yerel Kritik Boyut Tekdüzeliğini (LCDU) ve Model Yerleştirme Hatasını iyileştirir ve daha düşük bir doz sağlar.
Metroloji
Film kalınlıkları azaldıkça, metroloji sinyali-gürültü oranları bir sorun haline gelir.
EUV ile bir kusurluluk süreci penceresi vardır, bir tarafta kalıptaki kırılmaların sorun haline geldiği bir uçurum vardır ve pencerelerin diğer tarafında kalıplar arasındaki köprülerin sorun haline geldiği bir uçurum vardır.
Yeni bir adım atılmaya çalışıldığında, zamanla azalan birçok kusur vardır.
Yeterince geniş bir alanı yeterli hassasiyetle ölçmek zordur. E ışın denetimi hassastır ancak yavaştır, optik hızlıdır ancak hassas değildir. CFET gibi yeni 3B süreçler ek zorluklar getirir.
In “Yüksek NA EUVL için Kuru Dirençli Metroloji Hazırlığı” Gian Francesco Lorusso ve diğerleri, çok ince fotodirençlerin karakterizasyonu için Atomik Kuvvet Mikroskobu (AFM), E Işın incelemesi ve CD SEM'i araştırın.
Lam kuru fotodirenç prosesi kullanılarak CD SEM'in 5nm kalınlığa kadar fotodirençte geçerli olduğu gösterildi. Direnç kalınlığı azaldıkça çizgi pürüzlülüğü arttı, köprü kusurlarının basılabilirliği azalırken kopma kusurları aynı kaldı. Desen çökmesi yalnızca daha kalın filmlerde görüldü. AFM ölçümleri, film kalınlığının azaldığını gösterdi. E Beam, çok şey içeren filmler için bile kusurların iyi bir şekilde yakalandığını gösterdi.
In “3D çağ için yarı iletken metroloji” J. Bogdanowicz ve diğerleri, 3 boyutlu yapılar üzerinde metrolojinin zorluklarını keşfedin.
3B çağında, Z yönü yeni X/Y ölçeklendirmesi haline geldi. Mantıksal cihazlar için CFET ve Semi damascene zorluklar sunar, bellekte 3D DRAM gelecekteki bir zorluktur ve System Technology Co Optimization (STCO) için 3D ara bağlantılar başka bir zorluktur.
Yatay Nanosheet ve CFET süreçleri için yanal girinti ve dolgu karakterizasyonu ve çok katmanlı yığınlardaki kalıntıların ve diğer kusurların tespit edilmesi kritik olacaktır. 3D Bellekte yüksek en/boy oranlı (HAR) delik/bölünmüş profil oluşturma ve çok katmanlı filmlerdeki gömülü kusurları ve kalıntıları tespit eden mantığa benzer şekilde kritik olacaktır. STCO uygulamaları için bağlantı arayüzlerinin bütünlüğü ve hizalama anahtar olacaktır.
Geleneksel yüzey metrolojisi için hassasiyet ve hız arasında zaten bir ödünleşim vardır, şimdi inceleme derinliğine karşı yanal çözünürlük önemli bir değiş tokuştur. Şekil 5, çeşitli metroloji teknikleri için problama derinliğine karşı yanal çözünürlüğü ve verimi göstermektedir.

Şekil 6, çeşitli ihtiyaçları karşılamak için 3D metrolojinin mevcut durumunu özetlemektedir.

Şekil 6'dan itibaren, kapsamlı bir metroloji programı elde etmek için üstesinden gelinmesi gereken pek çok zorluk vardır.
Sonuç
Yüksek NA EUV dönemi yaklaşıyor. Zarcıklar, fotorezistler ve metrolojide kaydedilen iyi ilerleme var ve imec daha fazla ilerleme için her üç alanda da çalışmaya devam ediyor.
Ayrıca Oku:
TSMC, 300 mm'ye düşündüğünüzden çok daha fazla para harcadı
SPIE Gelişmiş Litografi Konferansı 2023 – AMAT Sculpta® Duyurusu
IEDM 2023 – 2D Materyaller – Intel ve TSMC
IEDM 2022 – Imec 4 İzleme Hücresi
Bu gönderiyi şu yolla paylaş:
- SEO Destekli İçerik ve Halkla İlişkiler Dağıtımı. Bugün Gücünüzü Artırın.
- PlatoAiStream. Web3 Veri Zekası. Bilgi Genişletildi. Buradan Erişin.
- Adryenn Ashley ile Geleceği Basmak. Buradan Erişin.
- PREIPO® ile PRE-IPO Şirketlerinde Hisse Al ve Sat. Buradan Erişin.
- Kaynak: https://semiwiki.com/lithography/329278-spie-2023-imec-preparing-for-high-na-euv/



