2.5D cihazın bir pakete sığacak şekilde küçültülmüş bir baskılı devre kartı mı, yoksa tek bir kalıbın sınırlarını aşan bir çip mi olduğunu tanımlamak, anlam açısından tüyler ürpertici gibi görünebilir, ancak genel başarı açısından önemli sonuçlar doğurabilir. bir tasarımın.
Düzlemsel çipler her zaman yaklaşık 858 mm olan retikül boyutuyla sınırlı olmuştur.2. Bunun ötesinde verim sorunları silikonu ekonomik olmaktan çıkarıyor. Yıllardır bu, düzlemsel alt tabakaya sıkıştırılabilecek özelliklerin sayısını sınırladı. Herhangi bir ek özelliğin ek çipler halinde tasarlanması ve bir baskılı devre kartına (PCB) bağlanması gerekir.
Gelişi 2.5D paketleme teknolojisi, genişleme için tamamen yeni bir eksen açtı; Chiplets bir iç mekanda birbirine bağlanmak gelişmiş paket. Ancak bu paketlenmiş tasarımın başlangıç noktasının, çeşitli bileşenlerin nasıl bir araya getirileceği, kimin dahil olacağı ve hangi araçların ne zaman konuşlandırılacağı üzerinde büyük etkisi olabilir.
2.5D'nin bugün zemin kazanmasının birkaç nedeni var. Biri maliyet. Gelişmiş paketleme çözümleri direktörü Tony Mastroianni, "Daha küçük çipler veya çipletler oluşturabilirseniz ve bu çipler bir pakete entegre edilecek şekilde tasarlanmış ve optimize edilmişse, bu her şeyi daha küçük hale getirebilir" diyor. Siemens Digital Industries Yazılımı. "Ve verim çok daha yüksek olduğu için bunun maliyet üzerinde çarpıcı bir etkisi var. Kalıp boyutlu talaşlar için %50 veya daha düşük verime sahip olmak yerine, bunu %90 aralığına çıkartabilirsiniz."
Bir PCB kullanarak yongaların birbirine bağlanması da performansı sınırlar. Eliyan'ın CEO'su ve kurucu ortağı Ramin Farjadrad, "Geçmişte çipleri ayrı ayrı paketliyor, ardından PCB'ye yerleştiriyor ve bazı yönlendirmelerle birbirine bağlıyorduk" diyor. “İnsanların yüzleşmeye başladığı sorunlar iki yönlüydü. Birincisi, bu çipler arasındaki bant genişliğinin PCB'den geçmesi ve ardından paket üzerindeki sınırlı sayıda top nedeniyle sınırlı olması ve bu çipler arasındaki bağlantıyı sınırlandırmasıydı."
2.5D'nin PCB'ye kıyasla temel farkı, 2.5D'nin çip boyutlarını kullanmasıdır. Çok daha ince taneli teller vardır ve çeşitli bileşenler, bir ara eleman üzerinde veya bir paket içinde, karta göre çok daha yakın bir şekilde paketlenebilir. Bu nedenlerden dolayı kablolar daha kısa olabilir, daha fazla olabilir ve bant genişliği artırılabilir.
Bu, performansı birçok düzeyde etkiler. Siemens'ten Mastroianni, "Çok yakın oldukları için, uzun nakliye RC veya LC gecikmelerine sahip değilsiniz, dolayısıyla çok daha hızlı" diyor. “Kart üzerinde uzun izler bırakmak için çip üzerinde büyük sürücülere ihtiyacınız yok, dolayısıyla daha düşük güce sahip oluyorsunuz. Çok daha iyi performans ve daha düşük güç elde edersiniz. Yaygın bir ölçüm, bit başına piko joule hakkında konuşmaktır. Bitleri hareket ettirmek için gereken enerji miktarı 2.5D'yi ilgi çekici kılıyor."
Yine de zihniyet başlangıçtaki tasarım konseptini etkiliyor ve bunun akış boyunca yansımaları var. Custom IC & PCB Group ürün yönetimi grup direktörü John Park, "Bir kalıp tasarımcısıyla konuşursanız, muhtemelen bunun sadece büyük bir çip olduğunu söyleyeceklerdir" diyor. Ritim. "Fakat bir paket tasarımcısıyla ya da kart tasarımcısıyla konuşursanız, bunun temelde küçük bir PCB olduğunu söyleyeceklerdir."
Kim haklı? Ürün pazarlama müdürü Marc Swinnen, "Buna nasıl yaklaşılacağına genellikle şirket içindeki iç organizasyon yapısı karar veriyor" diyor. Ansys. "Uzun vadede, şirketinizin fiziğine uymaya çalışmak yerine, şirketinizin fiziğe uyacak şekilde yapılandırıldığından emin olmak istiyorsunuz."
Açık olan şey hiçbir şeyin kesin olmadığıdır. Cadence's Park, "Dijital dünya çok düzenliydi; her iki yılda bir yarı büyüklükte yeni bir düğüm alıyoruz" diyor. "Bazı yeni gereksinimler olacaktı ama bu oldukça evrimsel bir süreçti. Ambalaj Vahşi Batı'dır. Bu yıl 8, gelecek yıl 3, gelecek yıl 12 yeni ambalaj teknolojisi alabiliriz. Bunların çoğu dökümhanelerden geliyor, oysa eskiden sadece dış kaynaklı yarı iletken montaj ve test şirketlerinden (OSAT'ler) ve alt tabaka sağlayıcılarından geliyordu. Dökümhaneler yeni bir katılımcı olsa da OSAT'lar gerçekten ilginç paketleme teknolojilerini daha düşük maliyetle sunuyor."
Bunun bir nedeni, farklı insan gruplarının farklı gereksinimlere sahip olmasıdır. Ansys'ten Swinnen, “Hükümet ve ordu, öncelikli faydaları heterojen entegrasyon yetenekleri olarak görüyor” diyor. “İşleme teknolojisinin sınırlarını zorlamıyorlar. Bunun yerine, çok yüksek hızlı sinyaller için dalga kılavuzlarına ihtiyaç duydukları monolitik mikrodalga entegre devreleri (MMIC'ler) gibi şeyler tasarlıyorlar. Buna ambalaj montajı bakış açısıyla yaklaşıyorlar. Bunun tersine, yüksek performanslı bilgi işlem (HPC) şirketleri buna yüksek performanslı yüksek bant genişlikli belleğe (HBM) sahip 5 nm ve 3 nm yonga yığınından yaklaşıyor. Bunu silikon montaj sorunu olarak görüyorlar. Gördükleri fayda, her bir yongayı yeniden tasarlamak zorunda kalmadan çekirdekleri ve arayüzleri bir araya getirip belirli pazarlar için ürünler yaratabilecekleri mimarinin esnekliğidir. Esnekliği fayda olarak görüyorlar. Ordu, heterojen entegrasyonu fayda olarak görüyor.”
Malzemeler
2.5D paketleme teknolojisinde alt tabaka olarak kullanılan çeşitli malzemeler vardır; bunların her biri maliyet, yoğunluk ve bant genişliği açısından farklı ödünleşimlere sahiptir ve her birinin üstesinden gelinmesi gereken farklı fiziksel sorunlar vardır. Farklılaşmanın ana noktalarından biri, şekil 1'de gösterildiği gibi tümsek eğimidir.
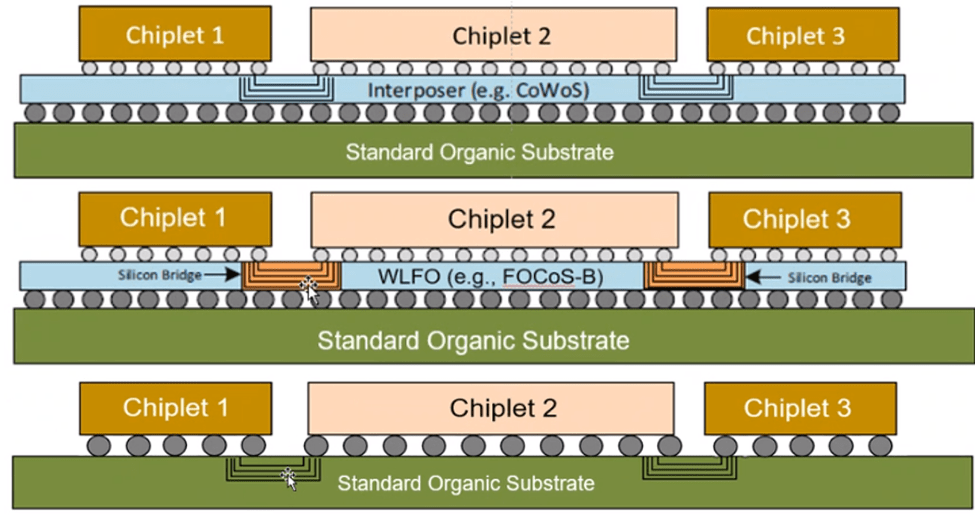
Şekil 1. Çeşitli alt tabaka konfigürasyonları için çiplet ara bağlantısı. Kaynak: Eliyan
Birinden bahsederken arabulucugenellikle silikon olarak kabul edilir. Eliyan'dan Farjadrad, "Aracı büyük bir silikon parçası (Şekil 1 üstte) veya bağlantıyı sağlamak için sadece çipler arasındaki silikon köprüler (Şekil 1 orta) olabilir" diyor. "Bu çözümlerin her ikisi de yüksek yoğunluğa sahip mikro darbeler kullanıyor. Aracılar ve köprüler çok sayıda yüksek yoğunluklu darbe ve iz sağlar ve bu da size bant genişliği kazandırır. Her biri 1,000 Gb'de çalışan 5 kablo kullanırsanız 5 TB elde edersiniz. 10,000'iniz varsa 50 TB alırsınız. Ancak bu sinyaller iki veya üç milimetreden fazla gidemez. Alternatif olarak, silikon aracıdan kaçınırsanız ve flip chip paketi gibi organik bir paket (Şekil 1 alt) kullanırsanız izlerin yoğunluğu 5 ila 10 kat daha az olur. Ancak tellerin kalınlığı 5 ila 10 kat daha fazla olabilir. Bu önemli bir avantaj çünkü tellerin direnci tel kalınlığının karesi kadar azalacaktır. Bu telin kesiti o telin karesi kadar artar, böylece direnç önemli ölçüde azalır. Eğer yoğunluk 5 kat daha azsa, bu, sinyalleri neredeyse 25 kat daha uzağa gönderebileceğiniz anlamına gelir."
Bazı insanlar için her şey milimetre başına bant genişliği ile ilgilidir. Donanım mühendisliği kıdemli müdürü Kent Stahn, "Paralel bir veri yolunuz veya yüksek hızlı bir paralel arayüzünüz varsa ve milimetre başına bant genişliği istiyorsanız, o zaman muhtemelen bir silikon aracı seçersiniz" diyor. Synopsus' Çözüm Grubu. “Organik bir substrat düşük kayıplı ve düşük maliyetlidir ancak yoğunluğu yoktur. Bunların arasında, bunların bir kısmını karşılayan ancak aynı maliyette olmayan bir dizi çözüm var."
Bir alt tabaka malzemesi seçmenin başka nedenleri de vardır. Synopsys Çözümler Grubu'nun kıdemli personel ürün müdürü Manuel Mota, "Silikon aracı bir dökümhaneden geliyor, bu nedenle kullanılabilirlik bir sorundur" diyor. "Bazı şirketler, kapasitenin tükenmesi nedeniyle gelişmiş paketlerin tedarik edilmesinde zorluklarla karşılaşıyor. Biraz daha az bant genişliği yoğunluğuna sahip, ancak belki de uygulamanız için yeterli olan diğer teknolojilere giderek bunları başka yerlerde bulabilirsiniz. Bu kritik bir husus haline geliyor.”
Ancak bu teknolojilerin tümü hızla ilerlemektedir. Park, "Retikül sınırı yaklaşık 858 mm karedir" diyor. "İnsanlar bunun dört katı büyüklüğündeki interpozerlerden bahsediyor ama bizim çok daha büyük laminatlarımız var. Japonya'dan gelen bazı laminat substratlar, silikondan alabileceğimiz ara bağlantı yoğunluğunun aynı seviyesine yaklaşıyor. Kişisel olarak organik substratlara doğru daha fazla baskı görüyorum. TSMC'nin Chip-on-Wafer-on-Substrate (CoWoS) teknolojisi bir silikon ara eleman kullanıyor ve yaklaşık 12 yıldır tercih edilen teknoloji. Daha yakın zamanda, organik türde bir substrata daha yakın olan film poliamid kullanan CoWoS-R'yi piyasaya sürdüler. Artık cam yüzeyler hakkında çok şey duyuyoruz.”
Zamanla paketin içindeki toplam gayrimenkul büyüyebilir. Park, "Dökümhanelerin 30 inçlik baskılı devre kartı boyutunda şeyler üretmeye devam etmesi mantıklı değil" diye ekliyor. “Daha büyük tasarımlara hitap edebilecek malzemeler var. Yoğunluğa gerçekten ihtiyaç duyduğumuz yer, ölmek için ölmektir. Bu yongaların birkaç milimetre ara bağlantı uzunluğunda yan yana olmasını istiyoruz. Çok kısa şeyler istiyoruz. Ancak geri kalanı sadece G/Ç'yi PCB'ye bağlanacak şekilde yaymaktan ibaret."
Köprülerin popüler olmasının nedeni budur. Synopsys'ten Stahn, "Arayüzün yüksek hızlı kısmı için köprülere doğru bir ilerleme görüyoruz" diyor. “Bunun arka tarafı RDL yayılımı gibi yayılacak. İlerleyen süreçte daha çok geleneksel paketlere benzeyecek RDL paketlerini görüyoruz."
Aracılar ek yetenekler sunar. Park, "Bugün aracıların %99'u pasif" diyor. “Hattın ön ucu yok, cihaz katmanı yok. Tamamen hat işlemenin arka ucu. O silikona üç, dört, beş metal katman ekliyorsunuz. Biz buna pasif aracı diyoruz. Bu sadece ölümden ölmeye ara bağlantıyı yaratıyor. Ancak o zarı alıp onu aktif bir aracı haline getiren, temelde buna mantık katan insanlar var."
Bu farklı amaçlarla gerçekleşebilir. Mota, "Zaten bazı şirketlerin güç yönetimi veya bazı kontrol mantıklarını ekledikleri aktif aracılar yaptığını görüyorsunuz" diyor. “Aktif devreleri aracıya yerleştirmeye başladığınızda, bu hâlâ 2.5 boyutlu bir entegrasyon mudur, yoksa 3 boyutlu bir entegrasyona mı dönüşür? Bugün aktif aracılara yönelik büyük bir eğilim görmüyoruz.”
Ancak bazı yeni sorunlar da var. Stahn, "Termal genleşme (CTE) uyumsuzluklarının katsayılarını dikkate almalısınız" diyor. "Bu, farklı CTE'lere sahip iki malzeme birbirine bağlandığında meydana gelir. Silikon aracıyla başlayalım. SoC'lerin akranlarıyla konuşabildiği ve çok fazla güç tüketebileceği daha yüksek voltajlı sistemler elde edebilirsiniz. Silikon ara elemanın yine de bir paket içinde olması gerekiyor. CTE uyumsuzlukları silikon ile ambalaj malzemesi arasındadır. Ve köprü sayesinde, onu ihtiyaç duyduğunuz yerde kullanıyorsunuz, ancak yine de silikon kalıptan ölmeye devam ediyor. Gönderdiğiniz gücün ve sahip olduğunuz CTE uyumsuzluklarının uygulanabilir bir sistemle sonuçlandığından emin olmak için termal mekanik analiz yapmanız gerekir."
Teorik olarak sinyal uzunlukları uzayabilirken, bu durum bazı sorunlara yol açmaktadır. Mastroianni, "Bir çipin içinde bu uzun bağlantıları yaparken, genellikle bu yolları birkaç milimetreyle sınırlandırırsınız ve ardından arabelleğe alırsınız" diyor. "Pasif silikon aracının sorunu, tamponların olmamasıdır. Bu gerçekten ciddi bir sorun haline gelebilir. Bu bağlantıları kurmanız gerekiyorsa bunları çok dikkatli planlamanız gerekir. Ayrıca zamanlama analizi yaptığınızdan emin olmanız gerekir. Tipik olarak, paket görevlileriniz bu analizi yapmayacaklar. Bu daha çok silikon mühendislerinin statik zamanlama analiziyle çözülen bir problem. Bir STA akışı tanıtmamız ve organik ve silikon tipi izler içeren tüm ekstraksiyonlarla ilgilenmemiz gerekiyor ve bu yeni bir sorun haline geliyor. Bu çok uzun izlerden bazılarına girmeye başladığınızda, normal STA gecikme hesaplayıcılarında varsayılan basit RC zamanlama gecikmeleriniz, bu izler arasındaki endüktansın ve karşılıklı endüktansın bir kısmını hesaba katmaz, dolayısıyla ciddi doğruluk sorunlarıyla karşılaşabilirsiniz. o uzun izler için.”
Aktif aracılar yardımcı olur. Swinnen, "Aktif aracılarla, tamponlar veya sinyal tekrarlayıcılar yerleştirerek bazı uzun mesafe sorunlarının üstesinden gelebilirsiniz" diyor. “Sonra tekrar çipe benzemeye başlıyor ve bunu yalnızca silikon üzerinde yapabilirsiniz. Intel'in EMIB teknolojisine sahipsiniz, çipletleri aracıya yerleştirdiler ve bu aktif bir köprü. Çip, EMIB çipiyle konuşuyor ve ikisi de sizinle bu küçük aktif köprü çipi aracılığıyla konuşuyor; bu çip tam olarak aktif bir aracı değil ama neredeyse aktif bir aracı gibi davranıyor."
Ancak pasif bileşenler bile değer katar. Mastroianni, "Yapılan ilk şey, ara elemana hendek kapasitörlerini dahil etmek" diyor. “Bu size, zara yakın bir yerde, önemli olduğu durumlarda iyi bir ayrıştırma yapma yeteneği veriyor. Bunları anakarta koyarsanız, yüksek hızlı arayüzlerin birçok avantajını kaybedersiniz. Eğer bunları aracıya yerleştirebilirseniz, hızlı değişen hız sinyallerinin olduğu yerin hemen altına yerleştirerek, yerelleştirilmiş bir ayrıştırma elde edebilirsiniz."
Farklı malzemelerin yanı sıra aracıyı kimin tasarladığı sorusu da var. Ansys'in ürün yönetiminden sorumlu kıdemli yöneticisi Matt Commens, "Sektör, tasarımı kimin yaptığı bağlamında bunu küçük bir PCB olarak düşünüyor gibi görünüyor" diyor. "Aralayıcılar, silikon prosesleri olmasına rağmen tipik olarak paketleme mühendisleri tarafından tasarlanıyor. Bu özellikle yüksek performanslı olanlar için geçerlidir. Mantık dışı görünebilir, ancak sinyal bütünlüğü geçmişine sahipler, iletim hatları tasarlıyorlar ve ara bağlantılardaki uyumsuzluğu en aza indiriyorlar. Geleneksel bir IC tasarımcısı bileşen bakış açısıyla çalışır. Yani kesinlikle endüstri bize, bu tasarım işi için görevlendirdikleri kişilerin paketleme tipi kişilikler olduğunu söylüyor."
Power
PCB'ler ve aracılar arasındaki yönlendirmede bazı önemli farklılıklar vardır. Verimli elektroniklerden sorumlu bölüm başkanı Andy Heinig, "PCB'ye kıyasla bileşen sayısı büyük ölçüde azaldığı için aracı yönlendirme çok daha kolay" diyor. Fraunhofer IIS/EAS. "Öte yandan, aracı üzerindeki güç şebekesi, metal katmanların daha yüksek direnci ve güç şebekesinin sinyal kabloları tarafından kesilmesi nedeniyle çok daha karmaşıktır. Kalıptan kalıba arayüzünün yönlendirmesi, yönlendirme yoğunluğu nedeniyle daha karmaşıktır."
Güç dağıtımı çok farklı görünüyor. Park, "PCB'ye baktığınızda, bu büyük metal dökme alanlarını katmanların içine yerleştirdiklerini ve bazı şeylerin geçmesi gereken alanları geçersiz kıldıklarını görürsünüz" diyor. “Bir miktar bakır koyarsın ve sonra diğerlerini geçersiz kılarsın. Bu şekilde bir aracı oluşturamayız. Ara bağlantıyı yerleştirmemiz gerekiyor, böylece silikon aracı üzerindeki güç ve toprak yapıları daha çok dijital bir çip gibi görünecektir. Ancak sinyal daha çok PCB veya laminat pakete benzeyecek."
Yönlendirme bir çipten çok bir PCB'ye benziyor. Park, "Daha iyi verim elde etmek için bir yastığa veya kanala bağlantı kurduğu yerlerde gözyaşı damlaları veya filetolar gibi şeyler göreceksiniz" diye ekliyor. “Günümüzdeki yönlendirme stilleri, yalnızca 90° dik köşelere ve temiz yönlendirme kanallarına sahip olduğunuz dijital IC'den ziyade PCB'lere daha uyumludur. Aracılar için, ister silikon ister organik olsun, yol genellikle klasik bir PCB sorunu olan telden daha büyüktür. Eğer dijitalden bahsediyorsak, yönlendiriciler yine bir kalıptan ziyade küçük bir PCB'ye benziyor.”
TSV'ler de sorun yaratabilir. Swinnen, "Bunları kare şeklinde ele alırsanız köşelerde çok fazla alan kaybedersiniz" diyor. “Bu nesnelerin çevresinde gerçekten 45° olmasını istiyorsunuz. Silikon yönlendiriciler geleneksel olarak Manhattan'dır, ancak tümseklerin bağlandığı üst katman olan RDL yönlendirmenin uzun bir geleneği vardır. Bu, geleneksel olarak sekizgen tümsekler veya yuvarlak tümsekler ve ardından 45° yönlendirmeyi kullandı. PCB yönlendirmesi kadar esnek değil, ancak yeniden dağıtım katmanı yönlendiricileri var ve ayrıca tam nehir yönlendirmesine sahip, tam özel taraftan gelen bazı yönlendiricileri var."
- SEO Destekli İçerik ve Halkla İlişkiler Dağıtımı. Bugün Gücünüzü Artırın.
- PlatoData.Network Dikey Üretken Yapay Zeka. Kendine güç ver. Buradan Erişin.
- PlatoAiStream. Web3 Zekası. Bilgi Genişletildi. Buradan Erişin.
- PlatoESG. karbon, temiz teknoloji, Enerji, Çevre, Güneş, Atık Yönetimi. Buradan Erişin.
- PlatoSağlık. Biyoteknoloji ve Klinik Araştırmalar Zekası. Buradan Erişin.
- Kaynak: https://semiengineering.com/2-5d-integration-big-chip-or-small-pcb/



