Önde gelen bir litografi teknolojisi için, EUV (aşırı ultraviyole) litografi hala bazı temel sorunlarla boğuşuyor. Stokastik olarak meydana gelen kusurlar muhtemelen en sık tartışılan konular olsa da, görüntü kaymaları ve solma [1-5] gibi diğer konular, yansıtıcı EUV optik kullanımının ayrılmaz bir parçasıdır. Bununla birlikte, bu stokastik olmayan konular sistematik olarak, sapmalar olarak etkili bir şekilde modellenebildiği sürece, düzeltici yaklaşımlar uygulanabilir.
Görüntü kaymaları, maske üzerindeki özellik konumu ve maske konumu dahil olmak üzere çeşitli nedenlerle EUV litografinin kaçınılmaz bir parçasıdır [6]. Bununla birlikte, maskenin herhangi bir konumunda ve üzerinde, görüntü kaymaları meydana gelir çünkü görüntü aslında EUV maskesinden daha küçük ve daha büyük yansıma açılarından gelen alt görüntülerden oluşur. Daha büyük açılar genellikle daha küçük genliklidir ve odaklama ile bir yönde kayarken, daha küçük açılar genellikle daha büyük genliktir ve odaklama ile ters yöne kayar. Kombine etki, odak dışı bırakma ile küçük bir net kaymaya sahip olmaktır (Şekil 1). Daha küçük ve daha büyük açılar için genlikler aynı olsaydı, kayma olmazdı [3].
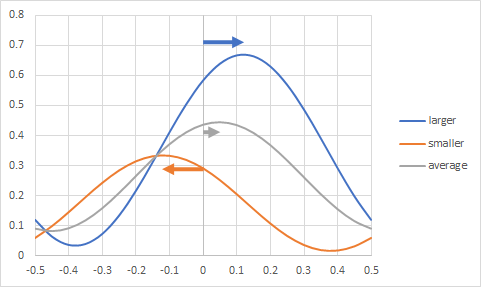
Ölçülen kaymalar ve en iyi odak konumu, hem aydınlatma açısının hem de perdenin [1] önemsiz olmayan işlevleridir. Şekil 2'den, 0.33 NA sistemindeki bu ölçümlere dayanarak, belirli perdeler için en uygun aydınlatmaları da seçebiliriz.

Örneğin, 32 nm yatay hat aralığı en iyi 0.8/0.5 dipol şekliyle (45 derece aralık, 0.5 iç sigma, 0.8 dış sigma) eşleşir. Öte yandan, 0.7/0.4 dipol şekli, yaklaşık 37 nm yatay hat aralığı ile en iyi şekilde eşleşiyor veya 37.3 nm'ye yakın görünüyor. Bu nedenle, ideal olarak, bu iki perdeyi içeren bir desen, biri 0.8 nm perdeyi içeren kısım için 0.5/32 aydınlatmalı ve diğeri 0.7 nm perdeyi içeren kısım için 0.4/37.3 aydınlatmalı olmak üzere iki parça halinde yazdırılmalıdır. Bu, bu iki perde için hem en iyi odak farkını hem de odak dışı görüntü kaydırma sorunlarını çözecektir.
Ancak vardiyayla ilgili başka bir sorun devam ediyor. En iyi odaktaki görüntü konumunun kendisi, farklı perdeler için farklıdır. Neyse ki bu Ref önerilen yöntemle basit bir şekilde düzeltilebilir. 4. Geçiş, farklı pozlama konumları olarak doğrudan telafi edilebilir. Ayrıca, dipol aydınlatmayı her monopol için bir tane olmak üzere iki poza bölerek sönümleme daha da ortadan kaldırılabilir [4]. Bu, iki kutbun her birinden gelen görüntülerin mükemmel bir şekilde örtüşmesine izin verir (Şekil 3). Bu, 32 nm ve 37.3 nm perdeler için toplam dört poz anlamına gelir. Ayrıca, vardiyaların iptal edilmesi için bindirmenin sıkı olması gerekir (<1nm). Doz, her maruz kalma için orijinal dozun 1/4'üne düşürülecektir. Bununla birlikte, verim yine de monopolün alt gözbebeği dolgusundan (<%20) zarar görebilir. Hafifletici bir olasılık, hedeflenen perdelerin en azından bazılarında gözbebeği dolgusunu artırmak için monopol genişliğini genişletmektir.

Bu çoklu pozlama yaklaşımı, daha fazla perdeyi kapsayan iki boyutlu modellere genelleştirilebilir. Maske konumu ve maske konumuna bağlı ayarlamalarla birlikte, EUV litografideki görüntü kayması sapmalarını tam olarak düzeltmenin tek gerçek titiz yoludur.
Referanslar
[1] F. Wittebrood ve diğ., ““EUV görüntülemede faz kaynaklı maske 3D efektlerinin deneysel doğrulaması,” 2015 Uluslararası EUVL Sempozyumu – Maastricht.
[2] T. Brunner ve diğ., "EUV karanlık alan litografisi: 0. sırayı bloke ederek aşırı çözünürlük", Proc. SPIE 11609, 1160906 (2021).
[3] F. Chen, "EUV Litografide Odak Dışı Kaynaklı Görüntü Kayması", https://www.youtube.com/watch?v=OXJwxQK4S8o
[4] Franke, TA Brunner, E. Hendrickx, "Aşırı ultraviyole görüntülemeyi iyileştirmek için ikili tek kutuplu maruz kalma stratejisi," J. Micro/Nanopattern. Anne. Metrol. 21, 030501 (2022).
[5] Proc. SPIE 3, 11147E (111470).
[6] F. Chen, "EUV Lithography'de Model Kaymaları", https://www.youtube.com/watch?v=udF9Dw71Krk
Bu makale ilk olarak LinkedIn Pulse'ta yayınlandı: Çoklu Monopol Pozlamaları: EUV Litografisinde Sapmaları Uysallaştırmanın Doğru Yolu?
Ayrıca Oku:
ASML – Zayıflığın üstesinden gelmek – Neredeyse dokunulmaz – Teslimat süreleri gerilemeyi aşıyor
Uygulamaya Özel Litografi: 0.0013 um2'nin altında DRAM Depolama Düğümü Modelleme
EUV Stokastik Kusurlarının Kökeni Olarak İkincil Elektron Bulanıklığı Rastgeleliği
Bu gönderiyi şu yolla paylaş:
- SEO Destekli İçerik ve Halkla İlişkiler Dağıtımı. Bugün Gücünüzü Artırın.
- Plato blok zinciri. Web3 Metaverse Zekası. Bilgi Güçlendirildi. Buradan Erişin.
- Kaynak: https://semiwiki.com/lithography/324136-multiple-monopole-exposures-the-correct-way-to-tame-aberrations-in-euv-lithography/



