Extreem ultraviolet (EUV) lithografiesystemen zijn de meest geavanceerde lithografiesystemen die momenteel in gebruik zijn. Dit artikel is een basisinleiding over deze belangrijke maar complexe technologie.
Het doel: een kleinere golflengte
De introductie van een golflengte van 13.5 nm zet een trend voort die de halfgeleiderindustrie volgde met een golflengtereductie sinds het gebruik van blauw licht (436 nm "g-lijn" golflengte) voor kenmerkafmetingen >1 micron. Het licht wordt geprojecteerd door een masker (of "dradenkruis") waarop het circuitpatroon is gedrukt. Het verzonden beeld wordt vervolgens verkleind wanneer het uiteindelijk op de wafer wordt geprojecteerd. De minimale toonhoogte is de helft van de golflengte gedeeld door de numerieke apertuur (NA) van het systeem. De NA van een optisch systeem is een dimensieloos getal dat het bereik van hoeken aangeeft waarover de uiteindelijke lens licht kan focussen. Golflengtereductie is niet triviaal, omdat het betekent dat de energie van de fotonen omgekeerd evenredig toeneemt. Bijgevolg is er een hoge absorptie in alle materialen. Er zijn dus volledig reflecterende off-axis optische systemen nodig. Dit heeft geleid tot de ontwikkeling van zogenaamde "ringveld"-projectiesystemen, die ertoe leiden dat de verlichting over het belichtingsveld roteert [1]. Pre-EUV optische systemen konden vertrouwen op op de as doorlatende optica, die de verlichtingsopstelling vereenvoudigde door geen rotatie te hebben.
Een ander masker
Het gebruik van de EUV-golflengte leidde ook tot een herziening van de maskerstructuur. Het masker is ook een reflecterend element. De reflectie wordt bereikt met een meerlaags bestaande uit ten minste 40 molybdeen/silicium dubbellagen. Het maskerpatroon maakt gebruik van een absorberende laag, momenteel gebaseerd op tantaal, die verschillende golflengten dik is. Met de off-axis verlichting die door het absorberpatroon wordt verspreid en zich voortplant en reflecteert door de multilayer, zijn 3D-effecten onvermijdelijk bij het beïnvloeden van het uiteindelijke beeld op de wafer [2].
Het masker wordt ook beschermd door een dun membraan, het vlies genaamd, dat op een bepaalde afstand van het maskeroppervlak staat. Het ontwikkelen van een vlies voor EUV was een groot probleem, omdat het licht er twee keer doorheen moet als een niet-reflecterend, doorlatend element.
Het numerieke diafragma wijzigen
De numerieke apertuur in de huidige EUV-systemen is 0.33. In een toekomstige generatie EUV-systemen wordt de numerieke apertuur vergroot tot 0.55. Dit zal naar verwachting 0.6x kleinere functiegroottes mogelijk maken, vanuit de golflengte / NA-proportionaliteit. De verwachting is echter dat de scherptediepte eronder zal lijden doordat deze sneller wordt verkleind dan de resolutie, aangezien deze ongeveer evenredig is met de golflengte/(NA)^2 (Afbeelding 1) [3]. Voor 0.55 NA EUV leidde dit tot problemen met het gebruik van resist (de absorberende beeldlaag op de wafer) zo dun als 20 nm [4].

Een 0.55 NA-systeem heeft extra complicaties. Ten eerste is het een halfveldsysteem, wat betekent dat er twee maskerscans nodig zijn om hetzelfde gebied te vullen als een enkele maskerscan in een eerder systeem [5]. Ten tweede is er een centrale verduistering geprojecteerd door de laatste twee optische elementen. Dit beperkt zowel de verlichting als bepaalde combinaties van toonhoogtes [6]. Ten slotte wordt polarisatie belangrijk voor toonhoogtes die gebruik kunnen maken van 0.55 NA [7].
De verduistering is het fundamentele systematische verschil dat de geprojecteerde schaling van de huidige 0.33 NA-systemen beïnvloedt. Er zal lichtverlies zijn vlak voordat het laatste scherpstelelement wordt bereikt. Bovendien zal de beeldkwaliteit fundamenteel veranderen. Sleutelcomponenten van het beelddiffractiespectrum. Figuur 2 toont een heldere lijn met een pitch van 68 nm onder belichting die is aangepast voor een pitch van 28 nm. Het uiterlijk is normaal zonder verduistering, maar als de verduistering op zijn plaats is, wordt de centrale piek verkleind en de zijlobben ernaast versterkt, aangezien de eerste diffractievolgorde is verwijderd. Deze zijlobben kunnen stochastisch afdrukken [8].
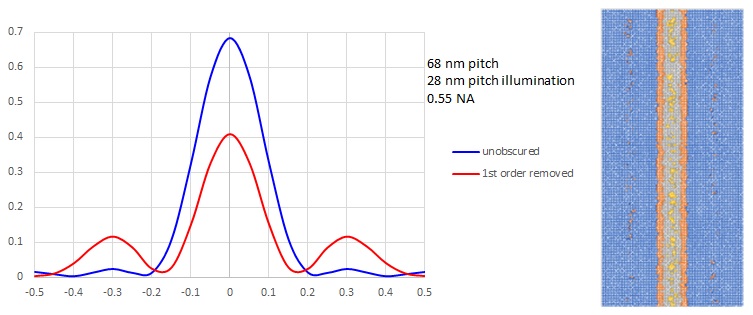
Het is niet alleen het EUV-licht...
EUV-lithografie wordt helaas geplaagd door een aantal factoren die niet duidelijk blijken uit de klassieke optische behandeling die tot nu toe is overwogen. Het EUV-licht is een vorm van ioniserende straling, wat betekent dat het bij absorptie elektronen vrijgeeft in de resist. De foto-elektronen (~ 80 eV) zijn afkomstig van de directe ionisatie en de secundaire elektronen zijn afkomstig van de ionisatie die hierdoor wordt veroorzaakt en vervolgens vrijgekomen elektronen. De energie die door de elektronenverstrooiing wordt afgezet, zal de resist duidelijk opwarmen, wat leidt tot ontgassing, wat de optische elementen in het EUV-systeem zal verontreinigen. Om deze reden bevatten EUV-systemen nu een minimaal absorberende waterstofomgeving die de oppervlakken van de optische elementen schoon houdt zonder ze te oxideren. Het is echter bekend dat waterstof ook blaarvorming veroorzaakt [9].
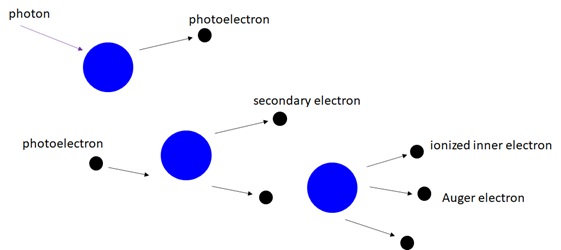
De elektronen verspreidden zich ook vanaf de oorspronkelijke fotonenabsorptieplaats, waardoor het oorspronkelijk gedefinieerde beeld wazig werd. De effecten van deze onscherpte zijn gemakkelijk voelbaar op enkele nanometers afstand. Het verspreidende effect wordt verder verergerd door de inherente willekeur van de hele reeks gebeurtenissen.
EUV onthult de stochastische aard van lithografie
Fotonabsorptie en elektronenverstrooiing zijn allemaal inherent willekeurige gebeurtenissen. Deze leiden tot CD-niet-uniformiteit en randruwheid, en zelfs plaatsingsfouten en ernstige defecten. Stochastische effecten zijn ernstiger met een lagere geabsorbeerde fotonendichtheid. Dunnere resists verminderen de absorptie, waardoor dit effect wordt versterkt. Een verhoogde fotonendichtheid leidt echter tot een grotere dichtheid van het aantal elektronen en een grotere vervaging van elektronen, waarvan de willekeur leidt tot stochastische defecten [10]. DUV-lithografie had geen rekening gehouden met stochastische problemen, voornamelijk omdat de kenmerkafmetingen groot genoeg waren om voldoende fotonen te beveiligen, maar EUV kon dit voordeel niet benutten.
Referenties
- Antoni et al., Proc. SPIE 4146, 25 (2000).
- Tanabe, Proc. SPIE 11854, 1185416 (2021).
- J. Lin, J. Micro/Nanolith., MEMS en MOEMS 1, (2002).
- https://www.imec-int.com/en/articles/high-na-euvl-next-major-step-lithography
- Davydova c.s., Proc. SPIE 12494, 124940Q (2023).
- https://www.youtube.com/watch?v=1HV2UYABh4E
- https://www.youtube.com/watch?v=agMx-nuL_Qg
- https://www.youtube.com/watch?v=sb46abCx5ZY
- https://www.youtube.com/watch?v=FZxzwhBR5Bk&t=3s
- https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen
Lees ook:
SPIE 2023 – imec bereidt zich voor op high-NA EUV
Kromlijnige maskerpatronen voor maximale lithografiemogelijkheden
Reality Checks voor High-NA EUV voor 1.x nm Nodes
Deel dit bericht via:
- Door SEO aangedreven content en PR-distributie. Word vandaag nog versterkt.
- PlatoAiStream. Web3 gegevensintelligentie. Kennis versterkt. Toegang hier.
- De toekomst slaan met Adryenn Ashley. Toegang hier.
- Koop en verkoop aandelen in PRE-IPO-bedrijven met PREIPO®. Toegang hier.
- Bron: https://semiwiki.com/lithography/329464-a-primer-on-euv-lithography/



